利用基片曲率法和光学技术相结合测量电化学腐蚀多孔硅薄膜结构的残余应力[27]。首先利用阴影云纹法、相移技术和数字图像处理技术相结合,对多孔硅薄膜/硅基底三维形貌进行测量,进而得到基底表面的平均曲率,最后根据Stoney公式计算多孔硅薄膜的残余应力,并分析孔隙率和基底掺杂浓度对残余应力的影响。
薄膜内残余应力的存在使膜-基复合体产生一定程度的弯曲变形。根据弹性力学理论,依据腐蚀膜前后基底曲率半径的变化,可求出残余应力的大小,Stoney给出了两者之间的关系:

式中,σr为膜内的平均残余应力;Es、Ef分别为基片和薄膜的弹性模量,Es=162GPa,Ef=156GPa;vs为基片的泊松比,vs=0.208;ts和tf分别为基片和薄膜的厚度;r0和r分别是基片腐蚀膜前后的曲率半径。
当薄膜厚度与基底厚度可比时,Stoney公式会有一定的误差,为此,Freund根据弹性力学理论对其进行了修正:

式中,h=tf/ts;m=Ef/Es。
采用直流电化学腐蚀法制作多孔硅薄膜。分别选用电阻系数为0.01~0.02Ω·cm的重掺杂硼离子P+型(100)方向的硅晶片和电阻系数为1~10Ω·cm的轻掺杂硼离子P-型(100)方向的硅晶片,将其切成24mm×9mm大小的试片。所用的腐蚀液为40%(质量分数)氢氟酸和无水乙醇配成体积比为1∶1的溶液。将硅晶片分别放入配置好的腐蚀液中,进行腐蚀的电流密度分别为80mA/cm2和40mA/cm2,腐蚀时间均为30min。多孔硅薄膜/硅基底试样薄膜厚度约为60μm,孔径约为2~10nm。
基片曲率法的应力测量装置见图4-59。将一平行光栅置于物体表面,并用一束与光栅表面法线夹角为α的光线照射,以在物体表面投射光栅条纹,通过移相装置实现多步相移;用面阵CCD采集变形条纹图,利用图像采集卡获得数字图像信息,经过计算机图像处理和运算实现三维轮廓测量和显示等功能;然后计算出物体表面的平均曲率半径,将变形前后的曲率半径代入式(4-18)、式(4-19),求得多孔硅薄膜的残余应力。
图4-60~图6-63所示为不同孔隙率的多孔硅薄膜的残余应力。多孔硅薄膜都呈现拉应力。随着孔隙率的增大,其对应的残余拉应力也相应增大。这表明残余应力的分布与多孔微结构有密切的联系。
此外,在重掺杂硼的P型Si基底上形成的薄膜的应力高于低掺杂硼的Si基底上薄膜的应力。这说明通过对基底进行掺杂,改变薄膜与基底的表面电子密度差可以控制薄膜中应力的大小。(https://www.xing528.com)

图4-59 基片曲率法的应力测量装置[27]
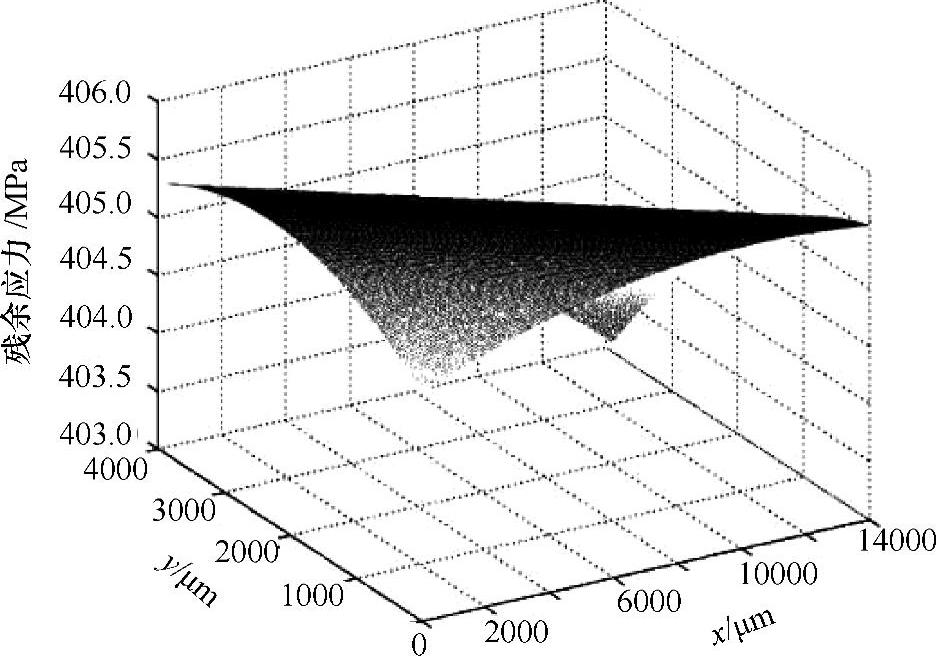
图4-60 孔隙率为70%的P+型多孔硅薄膜的残余应力[27]

图4-61 孔隙率为50%的P+型多孔硅薄膜的残余应力[27]

图4-62 孔隙率为45%的P-型多孔硅薄膜的残余应力[27]

图4-63 孔隙率为35%的P-型多孔硅薄膜的残余应力[27]
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




