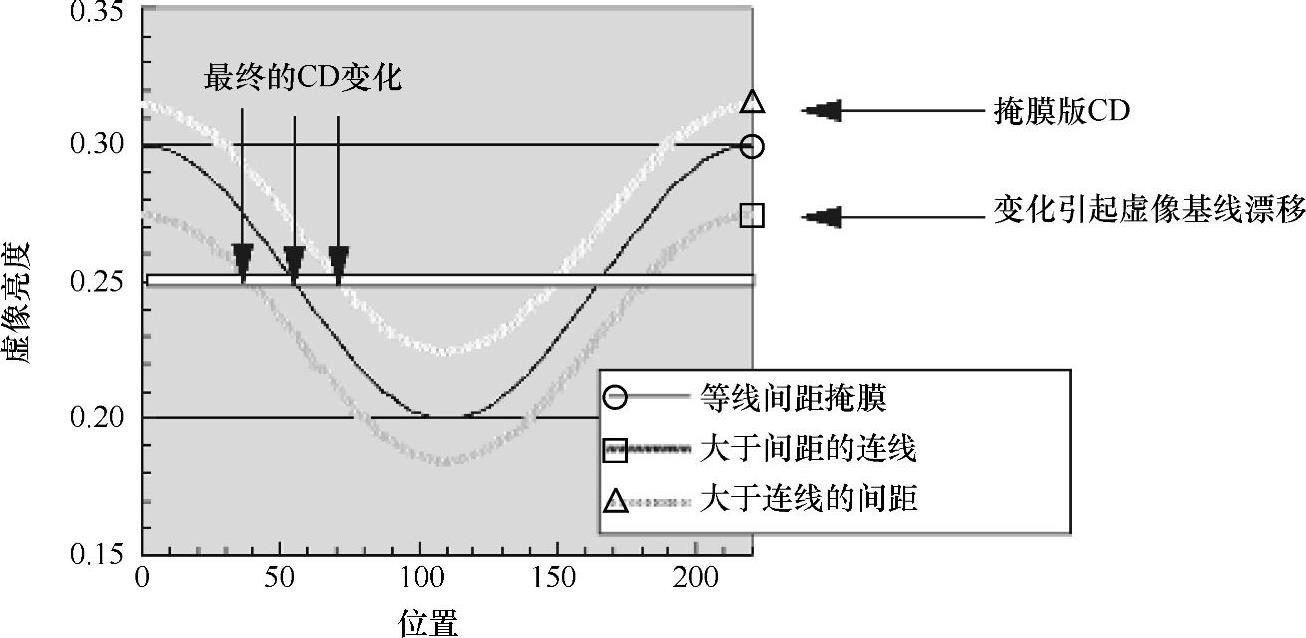
图3-10 空间像和MEEF
(掩膜版CD的变化引起基线的变化,进而转变为CD的变化。空间像斜率越小,CD变化越大)
掩膜误差增强因子(Mask Error Enhancement Factor,MEEF)描述了掩膜版上特征尺寸的误差与晶圆上实际特征尺寸最终误差的关系。MEEF是晶圆CD误差与掩膜CD误差之比。MEEF理想比值1之间发生的偏离是由于成像工艺的非线性造成的,并且将会随着k因子的下降变得更加显著。像许多其他的效应一样,MEEF在高k因子成像时并不受到关注。图3-10定性地解释了MEEF值大(https://www.xing528.com)
于1的原因。如图3-10所示,条宽与间距相等的线条图形的空间像是均匀背景和调制的叠加。我们主要关注条宽与间距相等情况的线条图形空间像的变化。假定掩膜版上的误差使铬膜线条宽度增加,在这一情况下,总的基线漂移来自于传输的平均光强漂移和调制的减小(第一衍射级强度减小;铬膜条宽和间距尺寸相等的情况下产生最好的传输)。空间像的斜率确定了交叉点位置基线漂移的敏感度。对低k成像引起的小的调制,即使较小的基线漂移也会导致关键的晶圆CD发生相当大的漂移。另一方面,较大的调制有更大的斜率,因此晶圆上CD的波动较小。该图也定性地表明,对于一定的节距,线条宽度与线条间距差别越大,产生的MEEF也越大。图3-11给出了条宽和间距尺寸相等情况下线条图形的定量估计。结果表明,采用0.75NA、193nm曝光工具,仅考虑空间像的贡献时,对非相干成像(σ=0.9),随着k因子的减小,MEEF将增加。当k减小到低于0.4的范围时,MEEF急剧增加。对于CD容限要求最严格的栅区光刻来说,这点特别重要,因为这时掩膜版CD误差对芯片线宽波动的影响最大。
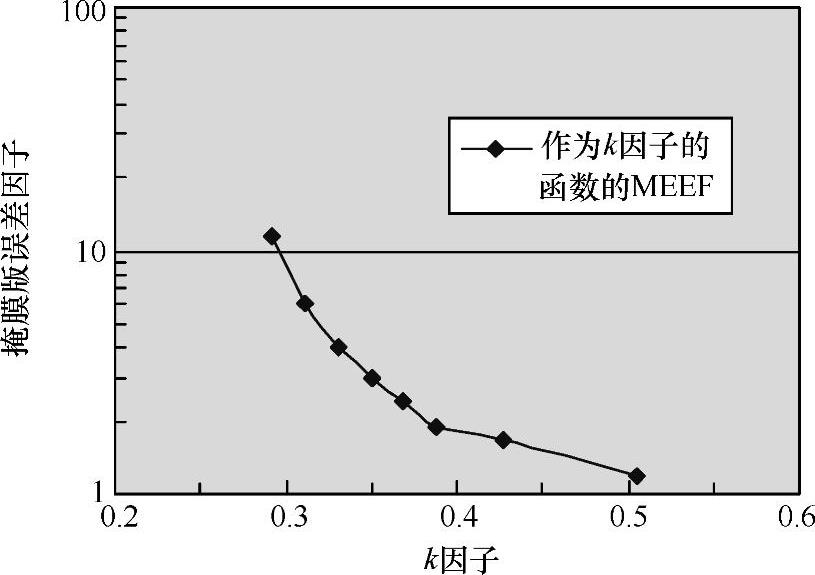
图3-11 MEEF与尺寸减小之间的关系
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




