【摘要】:H.J.Oh报道了在氧化硅上实现了生长砷化镓绝缘体,实现了在硅平台上生长的GaAs异质外延层,结合金属有机物化学气相淀积,成功地制作了InGaAs/HfO2的叠加结构,并规避了界面的费米能级钉扎的问题,NMOS场效应管比常规Si的快将近3倍。图5-72展示了利用GaAs为nMOS,Ge为pMOS的下一代硅基CMOS结构,有望成为下一代IC CMOS的首选电路单元。
互补型金属氧化物半导体场效应栅极长度接近10 nm以后,传统的CMOS缩放面临着根本性的限制。表5-6对比了几类相关半导体材料的电学资质。可以看到,由于GaAs系列的Ⅲ-Ⅴ化合物半导体的电子迁移率比硅材料要高出很多,所以有可能替代Si来制作nMOSFET,然而,Ⅲ-Ⅴ族MOSFET的挑战是:如何在硅的平台上集成高品质的GaAsⅢ-Ⅴ系列的沟道层材料,及其如何实现稳定的Ⅲ-Ⅴ/高k栅绝缘层界面,并且可以规避常见的费米能级钉扎现象。最近几年,薄膜的淀积技术有了长足的发展。H.J.Oh报道了在氧化硅上实现了生长砷化镓绝缘体,实现了在硅平台上生长的GaAs异质外延层,结合金属有机物化学气相淀积(MOCVD),成功地制作了InGaAs/HfO2的叠加结构,并规避了界面的费米能级钉扎的问题,NMOS场效应管比常规Si的快将近3倍。
而对于pMOS,由于锗硅异质结系列半导体的空穴迁移率比硅材料要高出很多,所以可用来替代Si制作pMOSFET。由于锗材料与硅材料的匹配较好,在硅的基底上制作锗硅系列的pMOS要相对的容易,M.T.Currie与张雪锋小组通过在高k介质和Ge表面引入HfO2/HfON叠层栅介质制作出的pMOS器件,有效迁移率可达到硅的两倍左右。图5-72展示了利用GaAs为nMOS,Ge为pMOS的下一代硅基CMOS结构,有望成为下一代IC CMOS的首选电路单元。
表5-6 几类半导体材料的电学性质(https://www.xing528.com)

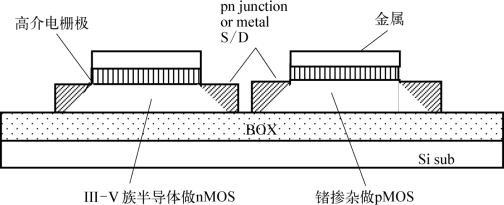
图5-72 下一代可能的CMOS结构图
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




