InAs/AlSbHEMT 器 件 典 型 结 构 如 图2.11 所 示。HEMT 器 件 中2DEG 层是通过宽禁带AlSb材料和窄禁带InAs材料两种半导体材料构成异质结来形成。紧密接触的异质结中,电子从宽禁带材料移动到窄禁带材料。为了提高器件沟道的2DEG 浓度,InAs/AlSbHEMT现在都采用调制掺杂,在势垒层中很薄的δ面掺杂Si作为施主杂质,δ面掺杂Si仅仅几个纳米,面掺杂层和沟道之间用空间层(Space layer)隔离。如图2.12所示,势垒层中δ面掺杂Si产生的电子移动到没有掺杂的沟道中,因为能量最低原理。电子运动到沟道后,留下了带正电荷的电离施主在面掺杂层,这样通过空间层把电离施主杂质和沟道中电子在空间上分开,最终减小了电离杂质散射的影响。沟道中电子被两边的势垒层限制在平面方向运动,形成2DEG,2DEG 的迁移率受到不同散射机构的影响。
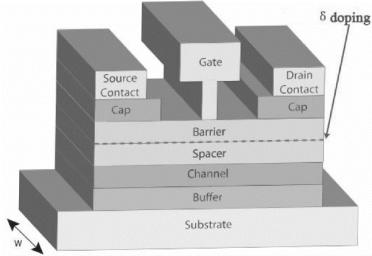
图2.11 HEMT 器件结构图
InAs/AlSbHEMT 器件除了要形成高二维电子气浓度和高载流子迁移率,同时HEMT 器件也要形成低欧姆接触阻值的源漏端,这要通过N 型高掺杂的InAs帽层来实现。帽层除了能减小有源区的导通阻值(Access resistances),同时还能保护下面材料层免受氧化或其他外界影响。栅极是肖特基接触,HEMT 器件通过栅极来控制源端和漏端间电流。为了避免源端,漏端和栅极之间短路,栅极下面的InAs帽层被去除掉。如图2.11 所示,T 型栅是为了减小栅电阻。
HEMT 器件的工作原理和场效应晶体管(FET)相似。漏源端加正电压来驱动2DEG 从源端到漏端的横向运动。当栅电压是负电压且足够大时,沟道中2DEG 浓度接近零,这时沟道夹断,称对应的栅极电压是夹断电压(Vp)。当栅极负偏压减小时,沟道中电子密度增加。但是,当栅极电压由负变正,正电压增大时,提高了2DEG 面密度,结果当源漏端电压也增大时,相应的器件电流也增大。HEMT 器件通过栅极调制了2DEG 面载流子浓度,使得器件导通和断开。
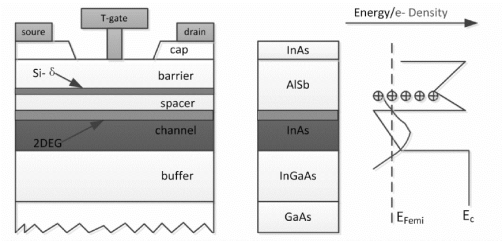
图2.12 HEMT 器件外延材料的导带图
定量描述HEMT 器件的工作原理,参数夹断电压(Vp)和阈值电压(VT)两个参数很重要。夹断电压是当掺杂的半导体材料全部耗尽时对应的栅极电压值,用公式2-24来计算:

式中q是电子电荷,ND是施主杂质浓度,εoεs是介电常数,d1是掺杂半导体厚度。同样,Vp,δ是δ 面掺杂层的所有电子全部转移到量子阱中需要的电压:

式中nδ是二维面δ 掺杂浓度,d*为栅金属到δ注入层的距离。
阈值电压(VT)是HEMT 器件处于临界导通状态,对应器件的栅电压是阈值电压。也就是阈值电压决定了器件开通和关断的电压。

式中qΦBn是肖特基势垒高度,阈值电压VT 可以通过不同的Vp和ΦBn进行调整大小,当给定半导体时,ΔEc的值是固定。耗尽型器件(通常是开态),当VG=0V 时,沟道中有电子存在,阈值电压VT 是负值。增强型器件(通常是关态),阈值电压VT是正值。当栅电压比阈值电压VT 高时,在2DEG 中面载流子浓度由公式2-27 来决定:
 (https://www.xing528.com)
(https://www.xing528.com)
式中x 是沟道中任意一点,VDs( )x 是沟道中源漏之间的电压。源端(x=0)VDs=0V,当x=Lg,VDs( )x 等于漏电施加的电压。同时,VGs 是栅源之间电压,Ci 是栅沟道电容,表达式如下:

式中d1,d2,d3分别是沟道(Channel)的厚度,掺杂层厚度,空间势垒层(Spacer)厚度。
一个沟道长度是LG,沟道宽度是W 的InAs/AlSbHEMT 晶体管,沟道中产生的源漏之间电流IDS可用下面公式计算:

式中μn是二维电电子气(2DEG)的载流子迁移率。
在VDS≪(VG-Vth )时,公式2-19中第二部分VDS2/2很小,可以忽略,则公式2-29简化为:

图2.13显示了HEMT 器件的IDS 和VDS 线性关系,那么这个区域称为线性区。线性区内,相应的沟道电阻(Rline)用公式2-31表示:

当VDS继续增加,耗尽区变得不对称,由于栅端和漏端反偏电压增大,导致靠近漏端的耗尽区比源端耗尽区大。当VDS 增大到VDS=VGS-Vth时,这时达到了饱和漏源电压(VDS_sat),漏端电场快速增加,这时沟道开始耗尽,也就是夹断。从这点开始,增加VDS 仅使IDS 有很小的增大,并且载流子速度达到饱和(vsat)。这个区域称为饱和区,饱和区IDS变为:


图2.13 InAs/AlSbHEMT 器件的I-V 特性曲线
跨导gm,定义为当固定源漏电压VDS,相对于栅压的漏电流的变化:
![]()
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




