1.输出特性
图3-8所示为功率MOSFET的输出特性曲线,它是以栅源电压UGS为参变量、反映漏极电流ID与漏源电压UDS间关系的曲线族。
输出特性可分成非饱和区、饱和区和截止区3个区域来考虑。
当0<UDS<UDSsat时处于非饱和区,其中UDSsat为饱和漏源电压,具体又可分为两段。UDS很小时,从源到漏的压降差很小,可以忽略不计,沟道可等效为电阻,ID随UDS线性增大,称为线性区;随着UDS增加,从源到漏的压降差变大,不可忽略,沟道厚度逐渐减薄,相当于沟道电阻增大,ID随UDS增大的速率变慢,称为可调电阻区。
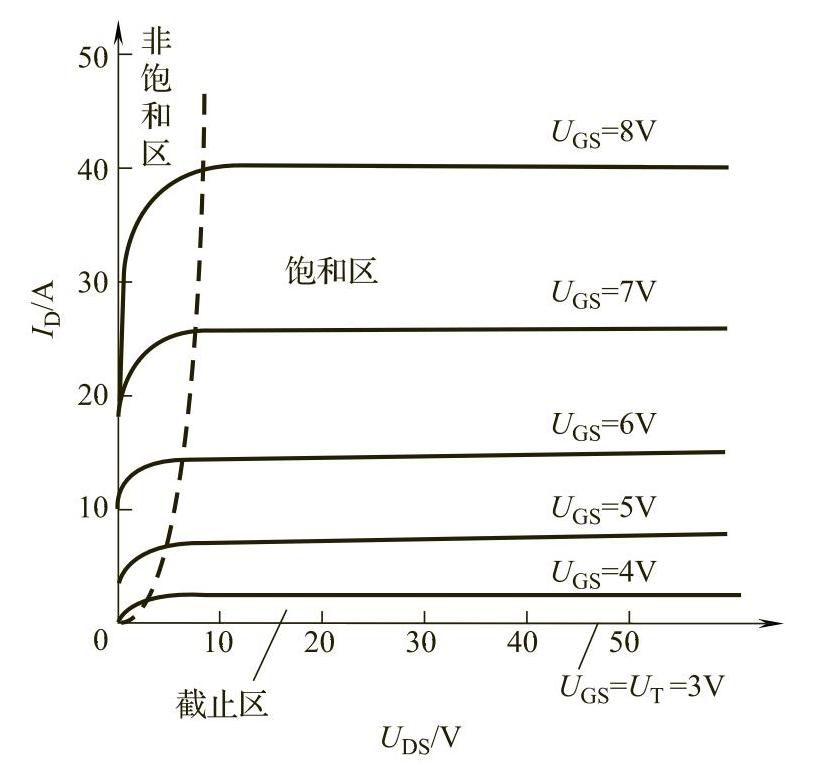
图3-8 功率MOSFET的输出特性曲线
定义增益因子

式中,μn为沟道中的电子迁移率;W/L为沟道的宽长比;Cox为栅氧化层电容。
在线性区,即UDS≪UGS-UT,满足如下关系
ID=β(UGS-UT)UDS
可见ID随UDS线性增加。
在可调电阻区,即UDS<UGS-UT,满足萨支唐方程

当UDS=UDSsat时处于饱和区,漏端沟道反型层消失,沟道在漏端被夹断,ID基本不随UDS而变化,达到饱和。此时UDS≥UGS-UT,满足

当UDS>UGS-UT时,沟道区压降仍UDSsat为,(UDS-UDSsat)这部分电压降落在沟道夹断点与漏区之间的耗尽层上,IDsat保持不变。
当0<UGS<UT时处于截止区,栅源电压低于阈值电压,半导体表面处于弱反型状态,ID很小,主要是PN结的反向泄漏电流。
如果施加在漏源之间的电压超过了漏区PN结的雪崩击穿电压,功率MOSFET将发生雪崩击穿,此时则对应于输出特性的雪崩区(图中未示出)。
2.转移特性
图3-9所示为功率MOSFET(增强型)的转移特性曲线,它表示UDS恒定时,漏极电流ID和栅源电压UGS的关系,表征功率MOSFET的UGS对ID的控制能力。

图3-9 功率MOSFET的转移特性曲线
3.动态特性
图3-10所示为功率MOSFET的开关过程,其中图3-10a为测试电路,图3-10b为开关过程的波形,这里的输入电压UI即UGS,输出电压UO即UDS。

图3-10 功率MOSFET的开关过程
a)测试电路 b)开关过程的波形
对于开通过程,从UI上升到峰值的10%的时刻起,到UO下降10%的时刻止,称为开通延迟时间,记为td(on);UO从下降10%到下降90%对应的时间段称为上升时间,记为tr;开通延迟时间与上升时间之和称为开通时间,记为ton,即ton=td(on)+tr。(https://www.xing528.com)
对于关断过程,从UI下降到峰值的90%的时刻起,到UO上升10%的时刻止,称为关断延迟时间,记为td(off);UO从上升10%到上升90%对应的时间段称为下降时间,记为tf;关断延迟时间与下降时间之和称为关断时间,记为toff,即toff=td(off)+tf。
功率MOSFET的开关速度和输入电容Cin充放电有很大关系。降低驱动电路内阻Rs可以减小时间常数,加快开关速度。功率MOSFET由于不存在少子存储效应,关断过程非常迅速,所以对于关断延迟时间td(off)这个时间常数有的书中也标记为ts,但它指的是栅极电容的存储作用,与GTR中超量存储电荷的作用是根本不同的。功率MOSFET的开关时间在10~100ns之间,工作频率可达100kHz以上,是主要电力电子器件中最高的。作为场控器件,静态时几乎不需输入电流,但在开关过程中需对输入电容充放电,仍需一定的驱动功率,并且开关频率越高,所需要的驱动功率越大。
4.安全工作区
图3-11所示为功率MOSFET的安全工作区,它由4条曲线围成:①是UDS的最大电压,即PN结的雪崩击穿电压,②是150℃时的最大功耗IDUDS,③是最大漏极电流IDmax,④是寄生晶体管的二次击穿限制。
正常工作状态下功率MOSFET的SOA中是不存在曲线④的,但是当源区下方的横向空穴流引起的电位差大于PN结阈值电压时,寄生NPN晶体管开通,SOA就受到寄生晶体管二次击穿的限制。

图3-11 功率MOSFET的安全工作区
5.主要电学参数
(1)导通电阻 导通电阻Ron是功率MOSFET的重要参数,它与输出特性、饱和特性密切相关。通常规定在确定的UGS下,功率MOSFET由可调电阻区进入饱和区时的直流电阻为通态电阻。
器件结构不同,Ron的计算方法也不同。以美国Motolora公司的TMOS(指器件重复单元为四边形,T代表Tetragon,又如器件重复单元为正六角形的称为HEXFET,HEX代表Hexagon)器件为例,如图3-12所示,Ron由4部分组成:
1)rCH:反型层沟道电阻,在低压器件中,这部分对Ron贡献较大,20V级功率MOSFET的rCH约占Ron的80%,高压器件中贡献较小。
2)rACC:栅漏积聚区电阻,指栅电极正下方在N-层上形成的表面电荷积累层电阻。
3)rJFET:夹断区电阻,指相邻的P阱间的电阻。

图3-12 TMOS导通电阻的组成
4)rD:轻掺杂漏极区电阻,指高阻外延层电阻,这部分在高压器件中非常重要,在大于500V的器件中占Ron的50%以上。
(2)跨导 参见图3-9功率MOSFET的转移特性曲线,ID较大时,ID与UGS的关系近似线性,曲线的斜率定义为跨导gm,即

跨导表征功率MOSFET的放大能力,与GTR的电流增益β相仿。
(3)漏源电流 ID是用来表示晶体管承受电流能力的一个参数。当功率MOSFET工作在电流饱和区时,ID与uGS满足如下关系

式中,Cox=εox/tox,εox=3.5×10-13F/cm,为二氧化硅的介电常数,tox为栅氧化层的厚度;μn为沟道区电子迁移率,μn≈700cm2/s·V;W为沟道宽度;L为沟道长度。
ID的大小主要受器件沟道宽度W的限制。
(4)其他 除前面提到的阈值电压UT以及td(on)、tr、td(off)、tf之外还有:
1)漏极电压UDS:它是功率MOSFET的电压定额。
2)栅源电压UGS:它与栅氧厚度有关,如:50nm厚的栅氧,30V的栅压可击穿,常见保险系数为3,所以允许的最大栅压为10V。
3)极间电容:包括CGS、CGD和CDS。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




