1.IGBT的静态特性
图3-57表示了IGBT的输出特性,即伏安特性,描述UGE为控制变量时,IC与UCE之间的相互关系。此特性与BJT的输出特性相似,不同的是控制变量。输出特性在第一象限可分为3个区域:正向阻断区、有源区和饱和区,在第三象限有反向阻断区。当UCE<0时,IGBT为反向阻断状态,J1结反偏,无论有无沟道都不会出现IC,J1结的雪崩击穿电压决定了IGBT的反向阻断电压URM。当UCE>0而UGE<UGE(th)时,IG-BT为正向阻断状态,J2结反偏,只有很小集电极漏电流流过,J2结的雪崩击穿电压决定了IGBT的正向阻断电压UFM。当UCE>0而UGE≥UGE(th)时,IGBT为正向导通状态,随着UCE的增大,导电沟道加宽,集电极电流IC增加,IC与UGE呈线性关系,而与UCE无关,这部分区域称为有源区或线性区。对工作在开关状态的IGBT应尽量避免工作于有源区。输出特性比较明显弯曲的部分为饱和区,在这个区域IC与UGE不呈线性关系。
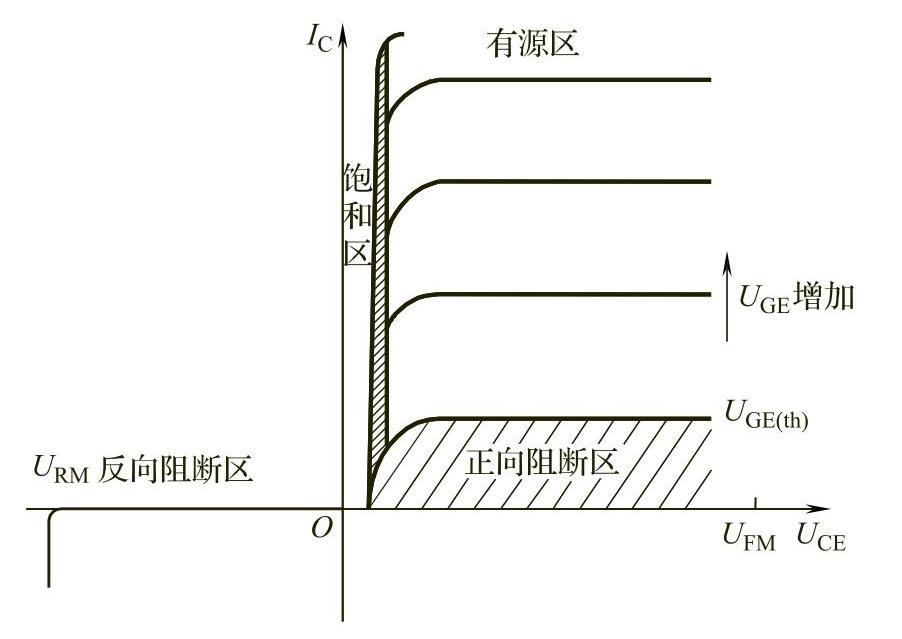
图3-57 IGBT的输出特性曲线
图3-58表示了IGBT的转移特性,描述的是IC与UGE之间的关系。由图可见除UGE(th)附近外,IC与UGE基本呈线性关系,这一点与功率MOSFET类似,相应的也可以定义跨导参数。图3-59所示为IGBT的饱和电压特性,由图可见IGBT的通态电压温度系数在小电流范围内为负,大电流范围内为正。这是因为在低电流区域,νBE、β等双极分量起支配作用,而大电流区域MOS分量沟道电阻Rch起支配作用。我们希望IGBT的通态电压具有正温系数,以便于并联应用,所以一般在大电流范围(交点以上)应用它。不过这个问题在现代IGBT器件中基本不存在,现代IGBT可实现全电流范围内的通态电压正温系数。另外,由于PNP管和功率MOSFET在这里是达林顿接法,所以存在PNP管发射结所需偏置电压UBE,UCE不是从0开始。

图3-58 IGBT的转移特性曲线
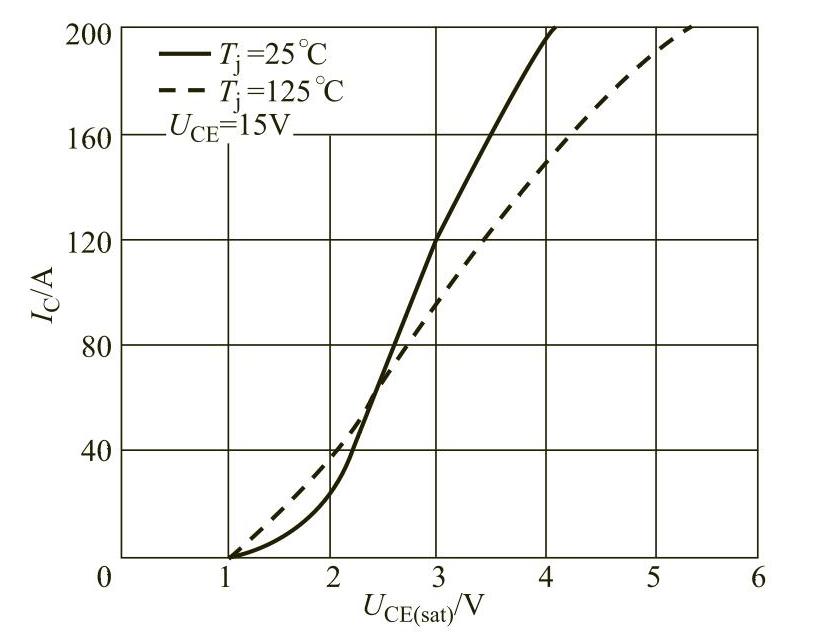
图3-59 IGBT的饱和电压特性
2.IGBT的动态特性
图3-60表示了IGBT的开关过程。对于开通过程,与功率MOSFET相似,可以定义两个开关时间。从UGE上升到峰值的10%时刻开始,到IC上升到峰值的10%时刻为止,定义为开通延迟时间,记为td(on)。IC从峰值的10%上升到90%的过程对应的时间定义为电流上升时间,记为tr。td(on)与tr之和为开通时间ton。UCE的下降过程可分为tfv1和tfv2两段,其中tfv1对应于IGBT中MOSFET单独工作的电压下降过程,其下降斜率较陡;tfv2对应于MOSFET和PNP晶体管同时工作的电压下降过程。

图3-60 IGBT的开关过程
对于关断过程同样可以定义两个开关时间。从UGE下降到峰值的90%时刻开始,到IC下降到峰值的90%时刻为止,定义为关断延迟时间,记为td(off)。IC从峰值的90%下降到10%的过程对应的时间定义为电流下降时间,记为tf。td(off)与tf之和为关断时间toff。电流下降时间tf又可分为tfi1和tfi2两段,其中tfi1对应IGBT器件内部MOSFET的关断过程,IC下降较快;tfi2对应IGBT内部PNP晶体管的关断过程,IC下降较慢。
图3-61更详细地表示了IGBT关断过程中IC和UCE的变化情况。IGBT中的电流包含MOSFET电流和双极电流两个分量。撤除栅压,反型沟道立即消失,MOSFET电流分量迅速衰减为零,即图中所示ΔIC,它等于PNP晶体管的基极电流,即ΔIC=(1-α1)IC。而双极电流分量必须经过类似双极型器件的复合关断过程,复合的快慢取决于载流子的寿命。因为对于IGBT中的PNP晶体管来说,基区没有直接的引出电极,所以不能利用外电路的驱动电流来缩短关断时间。虽然采用了类似达林顿的连接,关断时间比深饱和PNP晶体管要短,但仍不能满足许多高频应用的需求。这就是在很长一段时间内困扰IGBT发展的所谓“拖尾”电流问题,当然在现代高频大功率IG-BT中,“拖尾”电流已经得到了很好的解决。如图3-61所示,对于阻性负载,UCE是IC形状的反演。对于感性负载,UCE的陡然上升通常会过冲,在超过最后的稳态值之后再回来,不过由于关断过程电流分布比较均匀,所以只要设计简单的缓冲电路就可使IGBT正常工作。

图3-61 IGBT关断过程中IC和UCE的变化
IGBT的开关时间与集电极电流IC、栅极电阻RG以及结温等参数有关,尤其栅极电阻对开关时间的影响更大。图3-62所示为开关时间td(on)、tr、td(off)、tf分别随IC和RG的变化规律。图3-63表示了IGBT的开通损耗特性和关断损耗特性,图中一并列出了检测电路示意图,这里用到的是100A/600V的IGBT。对于开通损耗,温度上升100℃,导通损耗约增加一倍。关断过程取决于PNP晶体管的工况,与功率MOSFET相差很大,关断损耗也随温度上升而增加。由IGBT的饱和电压特性(见图3-59)、开通损耗特性和关断损耗特性可计算总功耗。例如,IC=40A,脉冲占空系数DF=50%,f=20kHz,Tj=125℃,则
PT=(UCE×IC)×DF+(Eon+Eoff)×f
=(2×40)×0.5+(2.2+2.1)×20=126W
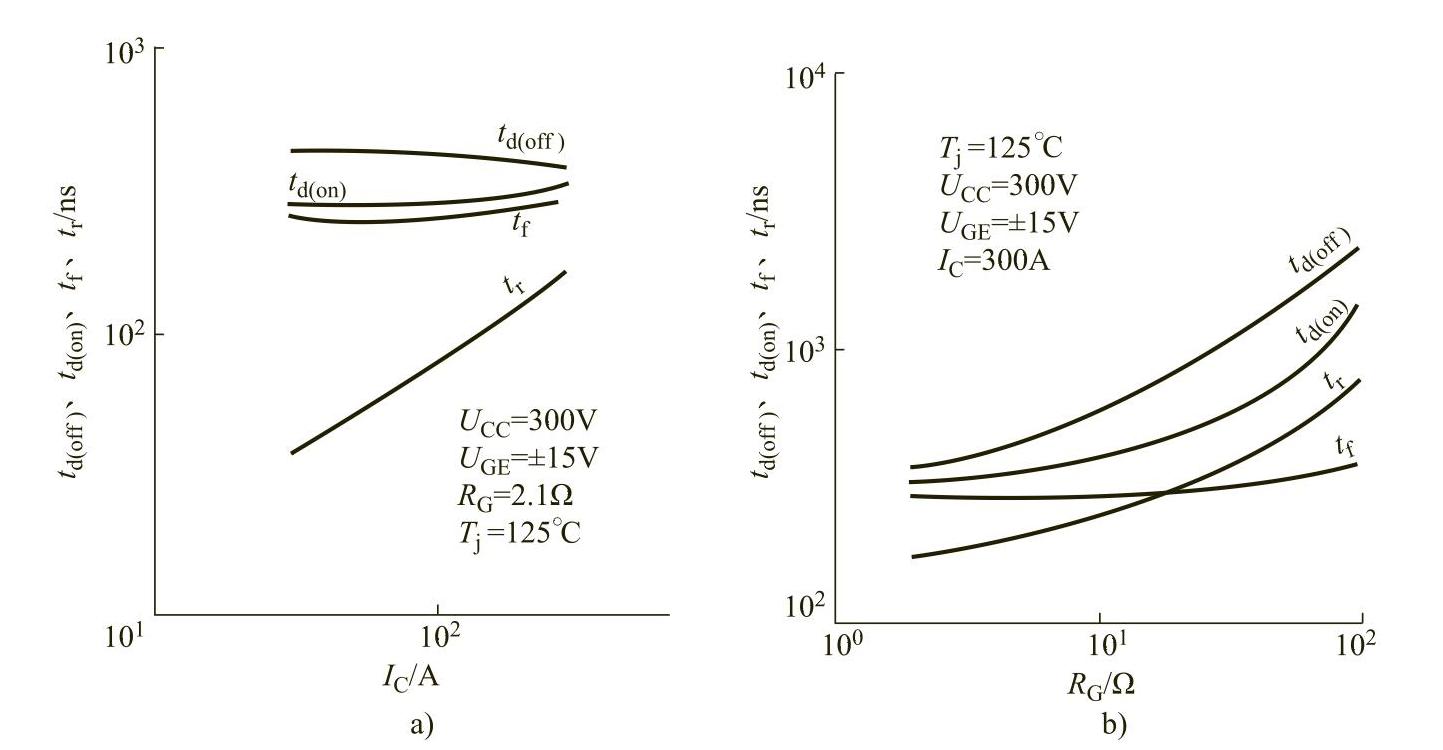
图3-62 开关时间td(on)、tr、td(off)、tf随IC和RG的变化规律
a)开关时间与IC b)开关时间与RG

图3-63 100A/600VIGBT开通和关断损耗特性
a)开通损耗特性 b)关断损耗特性
3.IGBT的擎住效应
擎住效应,也称晶闸管效应、闭锁效应,是指IGBT工作电流增大到某个值时,虽撤去栅偏压,器件依然导通,即器件被栅压触发导通后,栅压不再具有控制能力。此时器件处于不稳定状态,对IGBT而言是一种故障现象。擎住效应曾限制IGBT电流容量的提高,在20世纪90年代中后期开始逐渐解决。
从IGBT的基本结构可看出(见图3-56),单元的中间部分为P+N-P双极型晶体管,而位于两侧的P+N-PN+为晶闸管,它相当于一个MOSFET来控制晶闸管的结构,P层与源极金属化的地方相当于晶闸管的阴极短路点。当C加正电压,G相对E也加正电压,栅极下的N沟道导通,电子电流由源极流入N-并引起P+N-结向N-区注入空穴,该空穴被扫入P区后将形成P层中的横向流向“短路点”的电流。当横向电流引起的电位差大于等于0.7V时,将引起N+大量的电子注入,形成晶闸管式导通。一旦出现这种情况,两个等效晶体管因深度饱和处于锁定状态,即闭锁(latching)发生。
从考虑了寄生N+PN晶体管的等效电路图同样可以对擎住效应的发生机理进行解释。如图3-64所示,IGBT器件内有一个寄生晶闸管存在,它由P+NP和N+PN两个晶体管组成。在N+PN晶体管的基极与发射极之间并有一个体区电阻Rb,在该电阻上,P型体区的横向空穴流会产生一定压降。对于J3结来说,相当于加一个正偏置电压。在规定的漏极电流范围内,这个正偏压不大,N+PN晶体管不起作用。当漏极电流大到一定程度时,这个正偏置电压足以使N+PN晶体管导通,进而使N+ PN和P+NP晶体管处于饱和状态,于是寄生晶闸管开通,门极失去控制作用。

图3-64 考虑了寄生N+PN晶体管的等效电路图
IGBT出现擎住效应的条件就是寄生晶闸管开通的条件。设N+PN晶体管发射极电流为IE,则其集电极电流为IE·αNPN,此电流即为P+NP晶体管的基极电流,再经过P+NP晶体管放大,P+NP晶体管集电极电流放大βPNP=αPNP/(1-αPNP)倍输出,这个电流又成为N+PN晶体管基极电流,此反馈电流经N+PN晶体管放大后,发射极电流为IE·αPNP·αNPN/[(1-αPNP)·(1-αNPN)],令其等于I′E,当I′E≥IE时正反馈建立,PNPN晶闸管导通,整理得
αPNP+αNPN≥1
这也就是IGBT发生擎住的条件。
设空穴电流Ih流过N+源区下方,则引起的横向压降为UA=Ih·Rb,又Ih为P+NP晶体管的集电极电流,则Ih=αPNP·IC,IC为IGBT集电极电流,也就是P+NP晶体管的发射极电流,则UA=αPNP·IC·Rb,设晶闸管的导通条件是UA≥0.7V,所以IGBT发生擎住的临界擎住电流为

值得说明的是式(3-1)为静态擎住情况下的临界擎住电流表达式,关断过程中由于J2结反向电压的迅速建立,会引起较大位移电流而产生动态擎住效应,所允许ICL的比静态擎住的情况还要小。

图3-65 典型的擎住特性曲线
图3-65表示了典型的擎住特性曲线。其中,AB段为MOSFET栅控下的PNP管工作区;BC段为MOSFET栅控下的PNP管、NPN管共通工作区。此时,Rb上的压降逐渐增大,但NPN管仍然处于未导通状态,αPNP+αNPN<1;C点为正向转折点,对应的电压称为正向转折电压UBF,αPNP+αNPN≈1条件已满足,触发了PNPN寄生晶闸管的正反馈过程,使得IGBT发生擎住,阳极电流迅速增加;CD段为电流增大、压降减小的负阻区;DE段为J2结完全淹没后的等效二极管PIN区。(https://www.xing528.com)
根据式(3-1)容易看出,为了抑制擎住效应的发生,即应尽量提高ICL,可从减小αPNP和Rb两方面入手。具体到工艺上常用的防止擎住效应的措施包括:
1)减小短路电阻Rb。如采用P+中心扩散方法、缩短N+源区的横向长度等,图3-66表示的一种带有发射极腐蚀坑的元胞结构就有这样的设计考虑。在N+源区下的P阱区做一次P+深扩散,P+扩散窗口比P阱区小,目的是通过增加P阱区杂质浓度来减小Rb;发射极的腐蚀坑使IGBT形成槽栅结构,缩短了N+源区的横向长度L,L越小则Rb越小。此外采用自对准技术,可使发射极部分的N+区实现微细化,从多晶硅栅的侧壁扩散N+源区,由于不需要估计掩膜、对准和过腐蚀的余量,单元内多晶硅栅的间隔可由非自对准工艺的20μm左右缩短到7μm左右。
2)背面定域P+扩散法与阳极短路法。如图3-67所示,这两种方法实际上都从减小αPNP的角度提高了ICL,并且都可使存储在N-漂移区内的电子通过阳极短路部分泄放以加速关断。
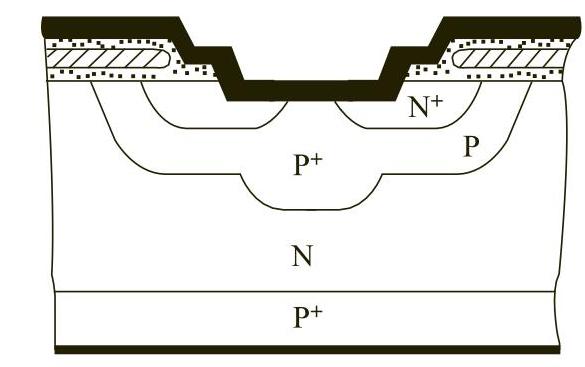
图3-66 带有发射极腐蚀坑的元胞结构

图3-67 背面定域P+扩散法与阳极短路法
a)背面定域P+扩散结构 b)阳极短路结构
3)加一薄的N+缓冲层。如图3-68所示,N+缓冲层的引入能防治擎住效应是容易理解的,N+层使PNP管P+衬底向N-外延层发射空穴的发射效率降低,从而使αPNP减小。
由于N+缓冲层具有协调器件通态、断态和开关特性的作用,可以说是一种奇妙的结构,特对其稍加说明。无N+缓冲层的IGBT中,正、反向阻断电压相等,故称对称型器件;有N+缓冲层的IGBT称非对称型器件。很多应用领域并不要求器件是对称型的(如电压型逆变器),所以非对称型器件很受重视。
如图3-69所示,对称型IGBT的电场呈三角形分布,而非对称型IGBT的电场呈矩形分布,所以N+缓冲层有利于提高正向阻断电压。需要注意的是在图3-69b中,正向阻断结J2的耗尽层决不允许穿通到J1结,因而缓冲层内电荷必须足以使电场在该区降到零,所以要适当提高掺杂浓度,但不能影响发射效率。
参考图3-56b所示的IGBT简化等效电路,设IGBT中的双极电流分量为IT,MOS电流分量为ID,IGBT中PNP晶体管发射结电压为UJ1,漂移区调制电阻端压为URN,IGBT中MOSFET端压为UDS,则IGBT的正向导通电压可表示为
UCE=UJ1+URN+UDS
=UJ1+IDRN+IDRon
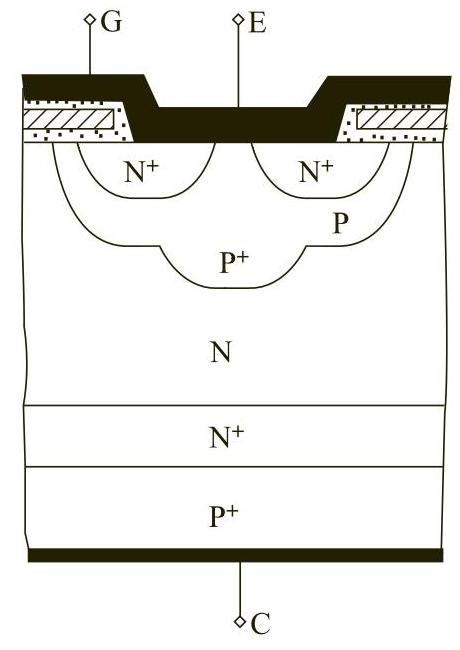
图3-68 加N+缓冲层的IGBT结构
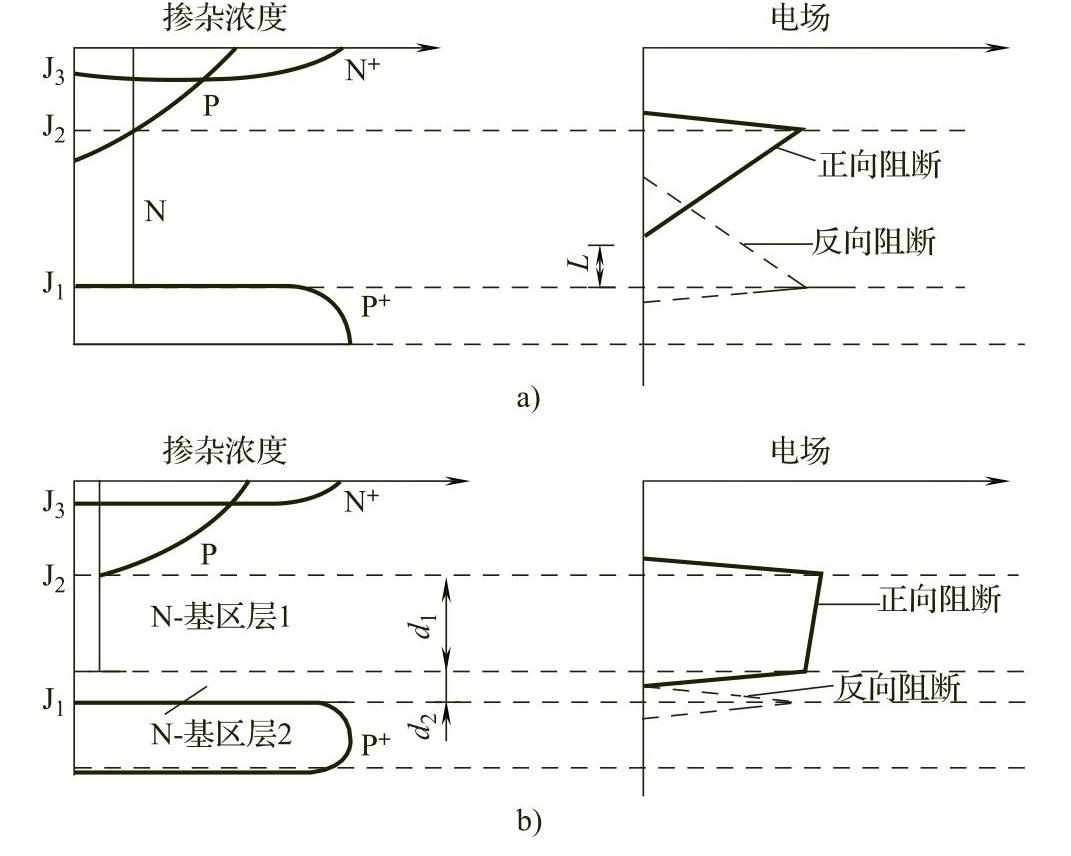
图3-69 N+缓冲层提高正向阻断电压
a)对称IGBT电场呈三角形分布 b)非对称IGBT电场呈矩形分布
可见,正向导通电压UCE取决于ID、漂移区调制电阻RN和MOSFET导通电阻Ron,而RN由漏区厚度决定,在非对称结构中,由于N+缓冲层的加入,N-漏区的厚度仅为对称结构的一半,故RN减小,UCE减小。
另一方面,IGBT中的总电流由双极和MOS两个分量组成,即
IC=IT+ID=βID+ID
式中,β为PNP管电流增益。
缓冲层降低了发射极注入效率,也就降低了β,则MOS电流分量将成为总电流的主要部分,而这部分电流是因沟道被切断迅速实现关断的,这部分电流越大,拖尾电流便越小,因而下降时间也越短。所以N+缓冲层结构的引入还可以缩短IGBT的关断时间。
综上,加入N+缓冲层的IGBT结构具有如下特点:抗擎住能力增强;正向阻断电压提高;正向导通电压减小;关断时间缩短;反向阻断电压减小(惟一被牺牲的特性)。鉴于N+缓冲层对改善功率半导体器件的功用,诸如功率二极管、GCT等也都经常引入该结构。为了协调各方的折中关系,N+缓冲层的掺杂浓度和宽度都需根据实际情况优化设计,一般而言,掺杂浓度在1016~1017cm-3量级,宽度约在10μm左右。
4)控制少数载流子寿命。通过中子、质子或电子线照射实现少子寿命的最佳控制可减小αPNP,以达到抑制擎住的目的。
5)选择合理的栅源结构。对于不同形式的元胞结构,如条形、方形、圆形,其抗擎住能力为:JL(条)>JL(方)>JL(圆)。
4.安全工作区
IGBT的主要参数包括:最大集射极间电压UCES——由内部PNP晶体管的击穿电压确定;最大集电极电流——包括额定直流电流IC和1ms脉宽最大电流ICP;最大集电极功耗PCM——正常工作温度下允许的最大功耗。
如图3-70所示分别为IGBT的正向偏置安全工作区(FBSOA)和反向偏置安全工作区(RBSOA)。其中,FBSOA由最大集电极电流、最大集射极间电压和最大集电极功耗确定,它与IGBT导通时间长短有关,导通时间越短,最大功耗耐量越高;RBSOA由最大集电极电流、最大集射极间电压和最大允许电压上升率duCE/dt确定,duCE/dt会使IGBT产生擎住效应,duCE/dt越大,RBSOA越小。
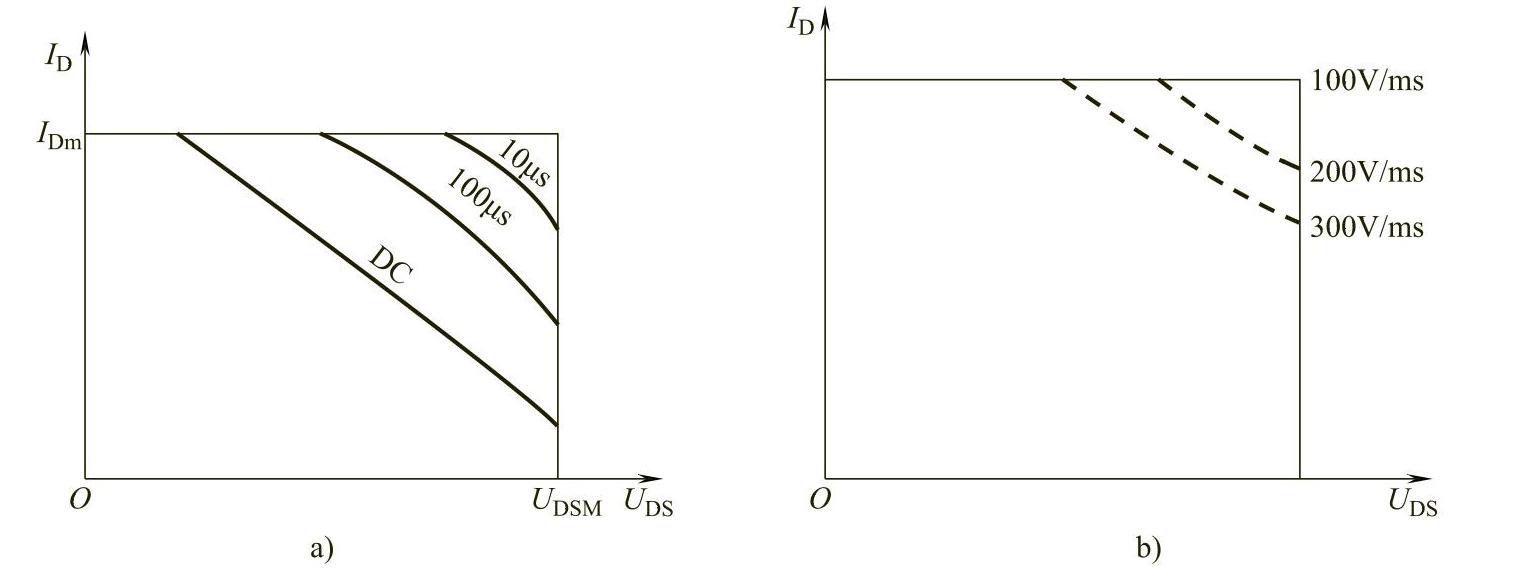
图3-70 IGBT的FBSOA和RBSOA
a)FBSOA b)RBSOA
IGBT的特性和参数特点可以总结如下:
1)开关速度高,开关损耗小。
2)相同电压和电流定额时,安全工作区比GTR大,且具有耐脉冲电流冲击能力。
3)通态压降比VDMOSFET低。
4)输入阻抗高,输入特性与MOSFET类似。
5)与MOSFET和GTR相比,耐压和通流能力还可以进一步提高,同时保持开关频率高的特点。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




