IGBT的开关作用是通过加正向栅极电压形成沟道,给PNP型晶体管提供基极电流,使IGBT导通。反之,加反向栅极电压消除沟道,流过反向基极电流,使IGBT关断。IGBT的驱动方法和功率MOSFET基本相同,具有高输入阻抗特性。当功率MOSFET的沟道形成后,从P+基极注入到N-层的空穴(少子),对N-层进行电导调制,减小N-层的电阻,使IG-BT在高电压时,也具有低的通态电压。
在通态中,IGBT可以按照功率MOSFET驱动的PNP型晶体管建模,假如发射极和集电极之间的压降不超过0.7V,即使栅信号让功率MOSFET沟道形成,集电极电流IC也无法流通。当沟道上的电压大于VGE-(th)时,电流处于饱和状态,输出电阻无限大。由于IGBT结构中含有一个双极型晶体管和一个功率MOSFET,因此它的温度特性取决于在属性上具有对比性的两个器件的净效率。功率MOSFET的温度系数是正的,而双极型晶体管的温度系数则是负的,VCE(sat)描述了作为一个集电极电流的函数在不同结温时的变化情况,IGBT的工作特性包括静态和动态两类。
1.静态特性
IGBT的静态特性主要有伏安特性、转移特性和开关特性。
(1)IGBT的转移特性
IGBT的转移特性是指输出集电极电流IC与栅极和发射极之间电压VGE的关系曲线。它与功率MOSFET的转移特性相同,当栅极和发射极之间电压小于开启电压VGE(th)时,IGBT处于关断状态。在IGBT导通后的大部分集电极电流范围内,IC与VGE呈线性关系。最高栅极和发射极之间电压受最大集电极电流限制,其最佳值一般取15V左右。转移特性曲线如图2-5所示。IGBT能实现电导调制而导通的最低栅极和发射极之间电压VGE(th),随温度升高而略有下降,在+25℃时,VGE(th)的值一般为2~6V。

图2-5 转移特性IC=f(VGE)
(2)输出特性(伏安特性)
IGBT的伏安特性是指以栅极和发射极之间电压VGE为参变量时,集电极电流与栅极电压之间的关系曲线。集电极输出电流受栅源电压VGE的控制,VGE越高,IG越大。
在截止状态下的IGBT,正向电压由J2结承担,反向电压由J1结承担。如果无N+缓冲区,则正反向阻断电压可以做到同样水平,加入N+缓冲区后,反向关断电压只能达到几十伏水平,因此限制了IGBT的某些应用范围。IGBT的基本输出特性如图2-6所示。其分为三个区域:正向阻断区、主动区域(放大区)和导通区域(饱和区)。分别与GTR的截止区、放大区和饱和区相对应。VCE<0时,IGBT为反向阻断工作状态。在正向导通的大部分区域内,IC与VCE呈线性关系,此时IGBT工作于放大区内。对应着伏安特性明显弯曲部分,这时IC与VCE呈非线性关系,此时IGBT工作于饱和区。开关器件IGBT常工作于饱和状态和阻断状态,若IGBT工作于放大状态将会增大IGBT的损耗。
第一象限显示IGBT模块可以承受高截止电压和关断大电流。对于第一象限的阻断特性来说,更为精确一点的定义应该是“阻断状态”(类似于晶闸管中的定义),但这一概念在晶体管中极少被用到。可使用正向截止状态或(在不引起混淆的情况下)截止状态这个名称。
通过控制极的作用,IGBT可以由正向截止状态(图2-6中的工作点OP1)转换至导通状态(OP2)。在导通状态下,器件可以通过负载电流。两种状态之间的主动区域(放大区)在开关过程中被越过。
不同于理想开关,器件的正向截止电压与通态电流均为有限值。在正向截止状态下存在一个残余的漏电流(正向截止电流),它将在晶体管内引起截止损耗。在导通状态下,主电路端子之间存在着一个依赖于通态电流的残余压降,被称为通态压降,它将引起通态损耗。在静态导通状态下(不是在开关过程中)的最大通态损耗在输出特性中由表征通态损耗的双曲线给出。
第三象限显示IGBT模块的反向特性,其条件是主电路端子之间被加上一个反向电压。这一区域的特性由晶体管本身的性能(反向截止型,反向导通型)及IGBT模块中的二极管特性(与晶体管串联或反向并联)所决定。

图2-6 IGBT基本输出特性
(3)开关特性
IGBT的开关特性是指集电极电流与发射极电压之间的关系,IGBT处于导通状态时,由于它的PNP型晶体管为宽基区晶体管,所以其β值极低。尽管等效电路为达林顿结构,但流过功率MOSFET的电流成为IGBT总电流的主要部分。此时,通态电压VCE(on)可用下式表示:
VCE(on)=Vj1+Vcr+ICRoh (2-6)
式中,Vj1为J1结的正向电压,其值为0.7~1V;Vcr为扩展电阻Rdr上的压降;Roh为沟道电阻。
通态电流ICE可用下式表示:
ICE=(1+βpnp)Imos (2-7)
式中,Imos为流过功率MOSFET的电流。
由于N+区存在电导调制效应,所以IGBT的通态压降小,耐压1000V的IGBT通态压降为2~3V,IGBT处于断态时,只有很小的泄漏电流存在。
IGBT关断速度的最大限制是N外延层(即PNP管的基区)中的少子寿命,因为这个基区不易受外电路影响,所以不能用外部驱动电路来缩短IGBT的开关时间。但是,因为PNP管采用伪达林顿接法,它没有存储时间并且它的关断时间远远大于深饱和状态的PNP管。虽然如此,在许多高频设备中IGBT仍然不适用。
由于基区内的存储电荷引起IGBT关断时电流波形出现延迟脉冲,使IGBT的电流不能迅速降低到空穴复合电流。这样不仅增加了关断损耗,而且在半桥式电路中,为了避免两只IGBT同时导通,必须在两只IGBT导通时间之间增加死区时间。
传统的减少少子寿命的工艺和加入收集少子的N+缓冲层,通常可缩短复合时间。但是这样由于PNP管的增益降低,导致IGBT电压降增加。减少少子寿命的工艺将造成IGBT出现准饱和导通状态,这样导通损耗将大于关断损耗。因此,PNP管的增益一方面受电导和导通损耗的限制,另一方面也受锁定状态的限制。像所有的少子器件那样,IGBT的开关性能将随温度升高而降低。
2.IGBT的动态特性
动态特性是指IGBT在开关期间的特性,鉴于IGBT的等效电路,要控制这个器件,必须驱动功率MOSFET器件。这就是说,IGBT的驱动系统实际上应与功率MOSFET的相同,而且复杂程度低于双极驱动系统。当通过栅极提供栅正偏压时,在功率MOSFET部分形成一个N沟道。如果这一电子流产生的电压处于0.7V范围内,PN结则处于正向偏压控制,少数载流子注入N区,形成一个空穴双极流。导通时间是驱动电路的输出阻抗和施加的栅极电压的一个函数。通过改变栅电阻RG值来控制IGBT的速度是可行的,通过这种方式,输出寄生电容Cge和Cgc可实现不同的电荷速率。换句话说,通过改变RG值,可以改变与RG(Cge+Cgc)值相等的寄生净值的时间常量,然后改变dv/dt。di/dt是RG的一个函数,栅电阻对IGBT的导通速率的影响是很明显的。因为RG数值变化也会影响dv/dt斜率,因此RG值对功耗的影响很大。当发送到栅极的信号降低到密勒效应初始值时,VCE开始升高。如前所述,根据驱动器的情况,VCE达到最大电平而且受到寄生电容Cge和Cgc的密勒效应影响后,电流不会立即归零,相反会出现一个典型的尾状,其长度取决于少数载流子的寿命。
在IGBT处于正偏压期间,这些电荷被注入到N区,由于寄生电容Cge和Cgc的存在,IGBT的动态特性受到寄生电容Cge和Cgc的密勒效应影响。降低这种有害现象有多种方式。例如,可以降低导通期间从P+基片注入的空穴数量的百分比,同时通过提高掺杂质水平和缓冲层厚度来提高重组速度。由于VCE(sat)增高和潜在的锁定问题,这种排除空穴的做法会降低电流的处理能力。
(1)IGBT的开通过程
IGBT的开通过程与功率MOSFET的相似,因为在开通过程中IGBT在大部分时间作为功率MOSFET运行,如图2-7所示。由于IGBT中双极型PNP晶体管的存在,虽然具有电导调制效应的优点,但也引入了少子储存现象,因而IGBT的开关速度低于功率MOSFET。IGBT的击穿电压、通态压降和关断时间也是需要折中的参数。IGBT的开通过程的时间参数有:
1)开通延迟时间td(on),指从VGE上升至其幅值10%的时刻起,到IC上升至10%ICM的时间。
2)电流上升时间tr,指IC从10%ICM上升至90%ICM所需时间。

图2-7 IGBT的开关过程
3)开通时间ton:开通时间ton为开通延迟时间与电流上升时间之和,即ton=td(on)+tr,VCE的下降过程分为tfV1和tfV2两段。tfV1是IGBT中功率MOSFET单独工作的电压下降过程;tfV2是功率MOSFET和PNP晶体管同时工作的电压下降过程。
IGBT在开通过程中大部分时间是作为功率MOSFET来运行的,只是在漏源电压Vds下降过程后期,PNP晶体管由放大区至饱和区,又增加了一段延迟时间。实际应用中常给出的集电极电流开通时间ton,即为td(on)和tri之和。
(2)IGBT的关断过程
IGBT的关断过程的时间参数有:
1)关断延迟时间td(off),指从VGE后沿下降到其幅值90%的时刻起,到IC下降至90%ICM的时间。
2)电流下降时间tf,指IC从90%ICM下降至10%ICM所需时间。
3)关断时间toff,指关断延迟时间与电流下降时间之和,即toff=td(off)+tf,电流下降时间又可分为tfi1和tfi2两段。tfi1是IGBT内部的功率MOSFET的关断过程,IC下降较快;tfi2是IGBT内部的PNP型晶体管的关断过程,IC下降较慢。
IGBT在关断过程中,集电极电流的波形变为两段。因为功率MOSFET关断后,PNP晶体管的存储电荷难以迅速消除,造成集电极电流较长的尾部时间,实际应用中常常给出集电极电流的下降时间tf,由图2-7中的tfi1和tfi2两段组成,而漏极电流的关断时间为
t(off)=td(off)+trV+t(f) (2-8)
式中,td(off)与trV之和又称存储时间。
(3)导通特性
从IGBT的等效电路可以看出,IGBT两端的电压降是两个器件的压降之和,PN结的结压降和驱动功率MOSFET两端的压降。因此,与功率MOSFET不同,IGBT的通态压降不可能低于二极管导通压降。另一方面驱动的功率MOSFET具有低压功率MOSFET的典型特性,它的电压降与栅极驱动电压有密切关系。当电流接近额定值时,栅极电压增加时,集电极-发射极之间的电压将下降。这是因为在器件工作范围内,PNP管的增益随电流增加而增加,使栅极电压增加引起沟道电流增加,因此PNP管两端的电压减小,这一点与高压功率MOS-FET差别很大。
作为伪达林顿接法的后级,PNP管绝不能深饱和,因此它的电压降高于深饱和PNP管,其原因是IGBT的发射极覆盖了芯片的全部面积。因此,IGBT的注入效率和导通压降都比同面积的双极型晶体管好得多。对器件设计来说,有两种减小导通压降的方法可供选择。
1)减小功率MOSFET的通态电阻,可通过增加芯片面积和组装密度来实现。
2)增加PNP管的增益,这个方法也受锁定因素的限制。
电导调制对导通压降有巨大影响,当器件的电流不同时,温度对导通压降的影响也不相同。这是因为电流较大时,二极管压降的温度系数由原来的负值变为正值。另一方面,功率MOSFET的压降的温度系数值为正值。在不同电流和温度时,两个器件的压降不同,使IGBT与功率MOSFET压降的差别更大。此外,电导调制还可以基本上消除器件的额定电压对导通压降的影响。表2-2列出了电流相同的四种额定电压的IGBT的导通电压值。
表2-2 导通压降与额定电压的关系

(4)栅极特性
IGBT的栅极通过一层氧化膜与发射极实现电隔离,由于此氧化膜很薄,其击穿电压一般只能达到20~30V,因此栅极击穿是IGBT失效的常见原因之一。在应用中有时虽然保证了栅极驱动电压没有超过栅极最大额定电压,但栅极连线的寄生电感和栅极—集电极间的电容耦合,也会产生使氧化层损坏的振荡电压。为此通常采用绞线来传送驱动信号,以减小寄生电感,在栅极连线中串联小电阻也可以抑制振荡电压。
由于IGBT的栅极-发射极和栅极-集电极间存在着分布电容CGE和CGC,以及发射极驱动电路中存在有分布电感Le,受这些分布参数的影响,使得IG-BT的实际驱动波形与理想驱动波形不完全相同,并产生了不利于IGBT开通和关断的因素。这可以用带续流二极管的电感负载电路得到验证,IGBT开关等效电路和开通波形如图2-8所示。
在t0时刻,栅极驱动电压开始上升,此时影响栅极电压VGE上升斜率的主要因素只有RG和CGE,栅极电压上升较快。在t1时刻达到IGBT的栅极门槛值,集电极电流开始上升。从此时开始有两个原因导致VGE波形偏离原有的轨迹。
 (https://www.xing528.com)
(https://www.xing528.com)
图2-8 IGBT开关等效电路和开通波形
a)等效电路 b)开通波形
1)发射极电路中的分布电感Le上的感应电压随着集电极电流IC的增加而加大,从而削弱了栅极驱动电压,并且降低了栅极-发射极间电压VGE的上升率,减缓了集电极电流IC的增长。
2)影响栅极驱动电路电压的因素是栅极-集电极电容CGC的密勒效应。t2时刻,集电极电流达到最大值,进而栅极-集电极间电容CGC开始放电,在驱动电路中增加了CGC的容性电流,使得在驱动电路内阻抗上的压降增加,也削弱了栅极驱动电压。显然,栅极驱动电路的阻抗越低,这种效应越弱,此效应一直维持到t3时刻,VCE降到零为止。它的影响同样减缓了IGBT的开通过程。在t3时刻后,IC达到稳态值,影响栅极电压VGE的因素消失后,VGE以较快的上升率达到最大值。
由图2-8中波形可看出,由于Le和CGC的存在,在IGBT的实际运行中VGE的上升速率减缓了许多,这种阻碍驱动电压上升的效应,表现为对集电极电流上升及开通过程的阻碍。为了减缓此效应,应使IGBT的Le和CGC及栅极驱动电路的内阻尽量小,以获得较快的开通速度。
IGBT关断时的波形如图2-9所示。t0时刻栅极驱动电压开始下降,在t1时刻达到刚能维持集电极正常工作电流的水平,IGBT进入线性工作区,VCE开始上升,此时栅极-集电极间电容CGC的密勒效应支配着VCE的上升,因CGC耦合充电作用,VGE在t1~t2期间基本不变,在t2时刻VGE和IC开始以栅极—发射极间固有阻抗所决定的速度下降,在t3时,VGE及IC均降为零,关断结束。
由图2-9可看出,由于电容CGC的存在,使得IGBT的关断过程也延长了许多。为了减小此影响,一方面应选择CGC较小的IGBT器件;另一方面应减小驱动电路的内阻抗,使流入CGC的充电电流增加,加快了VCE的上升速度。

图2-9 IGBT关断时的波形
在实际应用中,IGBT的VGE幅值也影响着饱和导通压降:VGE增加,饱和导通电压将减小。由于饱和导通电压是IGBT发热的主要原因之一,因此必须尽量减小。通常VGE为15~18V,若过高,容易造成栅极击穿。一般取15V。栅极驱动电压的上升、下降速率对IGBT开通关断过程有着较大的影响。理论上VGE≥VGE(th),IGBT即可开通,一般情况下VGE(th)=5~6V。当Vge增加时,通态压降减小,通态损耗减小,但IGBT承受短路电流能力减小;当VGE太大时,可能引起栅极电压振荡,损坏栅极;当VGE减小时,通态压降增加,通态损耗增加,但IGBT承受短路电流能力提高。
为获得通态压降最小,同时IGBT又具有较好的承受短路电流能力,通常选取VGE≥D×VGE(th),系数D=1.5、2、2.5、3。当VGE(th)为6V,系数D分别为1.5、2、2.5、3时,VGE则分别为9V、12V、15V、18V;一般栅极驱动电压VGE折中取12~15V为宜,12V最佳。IGBT关断时,栅极加负偏压,提高抗干扰能力,提高承受dv/dt能力,栅极负偏压一般为-10V。
IGBT的MOS沟道受栅极电压的直接控制,而功率MOSFET部分的漏极电流控制着双极部分的栅极电流,使得IGBT的开通特性主要决定于它的功率MOSFET部分,所以IGBT的开通受栅极驱动波形的影响较大。IGBT的关断特性主要取决于内部少子的复合速率,少子的复合受功率MOSFET的关断影响,所以栅极驱动对IGBT的关断也有影响。
在高频应用时,驱动电压的上升、下降速率应快一些,以提高IGBT开关速率降低损耗。在正常状态下IGBT开通越快,损耗越小。在开通过程中,如有续流二极管的反向恢复电流和吸收电容的放电电流,则开通越快,但IGBT承受的峰值电流也越大,越容易导致IGBT损坏。此时应降低栅极驱动电压的上升速率,即增加栅极串联电阻的阻值,抑制该电流的峰值。其代价是较大的开通损耗。改变栅极串联电阻的阻值,开通过程的电流峰值可以控制在任意值。
由以上分析可知,栅极串联电阻和驱动电路内阻抗对IGBT的开通过程影响较大,而对关断过程影响小一些,串联电阻小有利于加快关断速率,减小关断损耗,但过小会造成di/dt过大,产生较大的集电极电压尖峰。因此,对串联电阻要根据具体设计要求进行全面综合的考虑。
栅极电阻对驱动脉冲的波形也有影响,电阻值过小时会造成脉冲振荡,过大时脉冲波形的前后沿会发生延迟和变缓。当RG增大时,可抑制栅极脉冲前后沿陡度和防止振荡,减小开关di/dt,减小IGBT集电极尖峰电压;但IGBT开关时间延长,开关损耗加大。当RG减小时,减小IGBT开关时间,减小开关损耗;但当RG太小时,可导致G-E之间振荡,IG-BT集电极di/dt增加,引起IGBT集电极尖峰电压,使IGBT损坏。应根据IGBT电流容量和电压额定值以及开关频率选取RG值,如10Ω、15Ω、27Ω等。并在G-E之间并联一数值为10kΩ左右的RGE。
IGBT的栅极输入电容CGE随着其额定电流容量的增加而增大,为了保持相同的驱动脉冲前后沿速率,对于电流容量大的IGBT器件,应提供较大的前后沿充电电流。为此,栅极串联电阻的电阻值应随着IGBT电流容量的增加而减小。
(5)交换特性
由于IGBT一般用于起交换作用的用途,因此充分理解开通和关断时的交换特性非常重要。另外,由于该特性随各种参数而变化,因此有必要在考虑该特性的前提下进行装置的设计。交换特性可以大致分为交换时间和交换损耗两方面。首先,图2-10所示为交换时间的定义。有ton、tr、tr(i)、toff、tf、trr、Irr七个项目。由于交换时间随集电极电流、温度(Tj)、栅极电阻RG的变化而变化,设计装置的时应充分考虑。例如,在交换时间(特别是toff)变长的条件(RG较大等)下使用,可能出现由于空载时间不足而引发串联支路短路(即在一头的IGBT关断前,另一头的IGBT已经导通,从而流过过大的电流)等不良情况,从而导致IGBT损坏。另外,也可能在tr过短的条件下(由于RG过小等原因)使用,瞬态的电流变化(dIC/dt)变大,由于电路中的电感(LS)而产生的尖峰电压(LS dIC/dt)超出了反偏安全工作区(RBSOA)范围而导致IGBT损坏,需要充分注意。

图2-10 交换时间定义
另外,交换损耗(Eon、Eoff、Err)是在IGBT交换时(开通、关断时)发生的。该特性如图2-11、图2-12所示,交换损耗根据温度(Tj)、IC、RG而变化。其中特别是对RG的选定非常重要,如果过大,不但交换损耗变大,而且容易引起前面所述的由于空载时间不足而产生串联支路短路。

图2-11 交换损耗
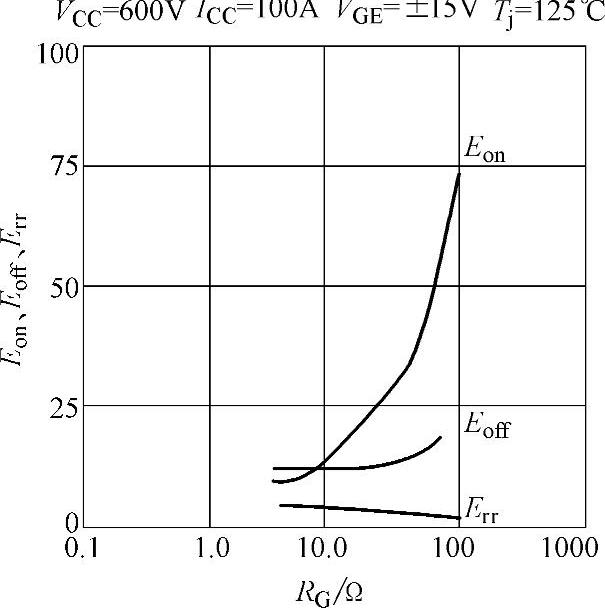
图2-12 交换损耗(RC)
在设计中,为了使交换损耗降到最低,而将RG变小时有可能出现的激烈的尖峰电压(LSdIC/dt)问题。从这里看出,选定RG受主电路电感(LS)的影响。由于该数值越低,选定RG就变得越容易(即使RG小,尖峰电压也不容易出现),因此尽量将LS的值设计得小一些。另外,选定RG时必须考虑与IGBT的驱动电路中电容的协调性。
(6)电容特性
图2-13所示为IGBT栅极充电电量Qg的特性。该特性表示了相对于栅极充电电量Qg,集电极-发射极间的电压(VCE)和栅极-发射极间的电压(VGE)变化。由于Qg增加表示IGBT的G—E间的电容中有电荷被充入,一旦Qg充电,VGE(Qg/C—E间电容)上升,IGBT即开通。当IGBT开通时,VCE也随之下降到通态电压。如上所述的栅极充电电量Qg表示了驱动IGBT所需的电荷量。在驱动电路设计中应充分利用该特性。
图2-14所示为IGBT的各结电容的特性,在图2-15中,Cies是指栅极—发射极间的输入电容,Coes是指集电极-发射极间的输出电容,Cres是指集电极-栅极间的反向传输电容。在IGBT驱动电路设计中应充分利用上述特性和Qg特性。

图2-13 栅极充电电量(Qg)的特性

图2-14 IGBT各结电容的特性
(7)内置二极管(FWD)特性
在IGBT模块中,高速二极管(下称FWD)与IGBT反并列连接,内置于模块中。该FWD具有图2-16所示的VF-IF特性和图2-17所示的反向恢复特性(trr、Irr)、以及图2-11、图2-12所示的反向恢复工作时交换损耗(Err)特性。另外,由于FWD的特性随集电极电流、温度、RG等因素变化,在电路设计中需要加以注意。

图2-15 IGBT结电容

图2-16 VF-IF特性

图2-17 反向恢复特性
(8)瞬态热阻特性
图2-18所示为温度上升时的瞬态热阻特性(该特性为IGBT、FWD每一个元件的特性)。该热阻是在进行热分析时经常使用的特性,被定义为类似于电阻的欧姆定律的公式:
ΔT=RthPW (2-9)
式中,ΔT为温度差(℃);Rth为热阻(℃/W);PW为能量(损耗)(W)。
(9)IGBT并联电流分配的关系

图2-18 瞬态热阻特性
IGBT并联连接时理想的配线方法是“均一并且最短”,从装置的量产化观点来看,很难完全满足这个要求。因此,需要尽可能地向接近理想化方向开展工作,为此,IGBT模块在并联连接时,受栅极电路配线的电感和IGBT的输入电容的影响,栅极电压上升时有时会产生寄生振荡,为了防止这种振荡,要在IGBT各栅极上串联栅极电阻。驱动电路的发射极配线被连接在与主电路不同的位置时,并联连接的器件的瞬态性电流分配(特别是开通时)变得不均衡。然而,在IGBT模块中设置了驱动电路的辅助发射极端子,只要使用这个端子,驱动配线便能够均等配线,能够抑制由驱动电路的配线而引起的瞬态性电流不均衡。另外,从器件引出的配线应从中央部伸出,紧密拧成一体,尽量远离主电路配线,布局时注意避免相互受到感应。
当主电路配线的电阻部分和电感部分不均等的时候,并联连接的元件的电流分配会产生不均衡。另外,如果主电路配线的电感部分大,IGBT关断时的浪涌电压将变大。因此,为了减低配线的电感和平衡各IGBT模块的温度,应考虑将并联连接的IGBT模块尽可能紧密地配置,配线要尽可能均等化。另外,将集电极和发射极的伸出线从中央部位伸出,为避免相互感应,伸出线不要与集电极和发射极的配线平行配线。
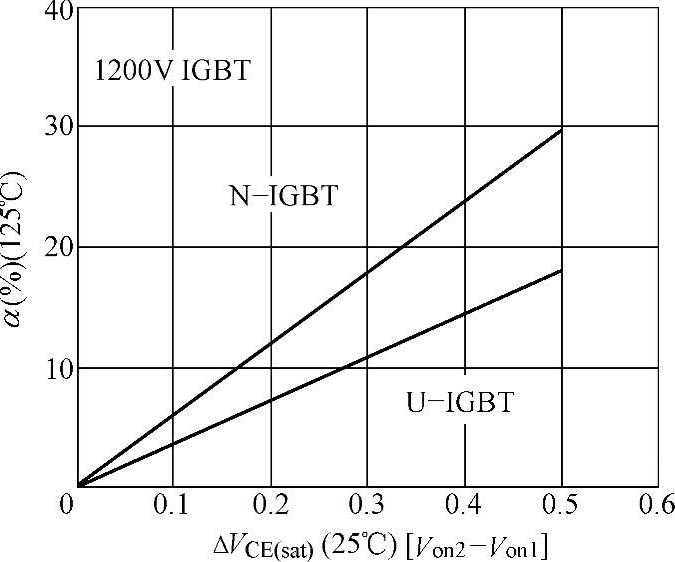
图2-19 VCE(sat)的不均性和电流分配的不均衡的关系
VCE(sat)的不均性是器件本身的特性,是影响电流分配的因素。n个器件并联连接时,设可流过的最大电流集中流过1个元件的情况作为最坏的条件,则

在此,可以表示为

在此,IC(max)表示器件额定值或发生损耗所容许的每个器件的最大电流,由于发生的损耗因使用条件(交换频率、驱动条件、散热条件、缓冲条件等)的不同而有差异,设计中需要特别注意。
比如α=16%、IC(max)=200A、n=4时,可计算出ΣI=634.4A,设计时,并联连接的全电流不要超过该ΣI。即使n=4,也不是单纯地ΣI=200A×4=800A。
图2-19所示为VCE(sat)的不均性和电流分配的不均衡的关系,U系列IGBT与N系列IGBT输出特性比较如图2-20所示,由于其输出特性的温度系数为正特性,因此与N系列的IGBT相比,电流不平衡率α变小了。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




