SOS是借助于可控等离子层换流的思想来进行工作的。为说明SOS效应并研究SOS中的关断过程,S.A.Darznek等人建立了可分析大注入条件下电子—空穴动力学的模型。模型考虑了P+PNN+结构的掺杂剖面及以下电子—空穴基本过程:强场中载流子的扩散和漂移、深能级杂质的复合、俄歇复合、密集等离子体的碰撞离子化。
在如图4-72所示电路中,描述电流的基尔霍夫方程为

式中,UC和IC为等效电容上的电压和流过电容的电流;US和IS为SOS上的电压和电流;Ce和Le为电路的等效电容和电感,正向泵浦过程中分别为C+和L+,反向泵浦过程中分别为C-和L-。
变量UC,IC和US的初始条件为
UC(0)=U0,IC(0)=0,US(0)=0
图4-77为典型的SOS掺杂剖面结构,包括4个特征区域:通过扩硼获得的高掺杂P+区Ⅰ;通过扩铝获得的中等水平掺杂的P区Ⅱ;磷轻掺杂的N区Ⅲ;扩磷的N+区Ⅳ。二极管P+PNN+结构在SOS效应机制下运行时,采用准中性等离子体近似,对非均匀掺杂半导体剩余等离子体浓度p有如下表达式

式中,Da为双极扩散系数, ;Va为双极漂移速率,
;Va为双极漂移速率,
 ;Qp为频率参数,
;Qp为频率参数, ;G为电子-空穴对的体产生率;电子和空穴的扩散系数分别为:Dn=40cm2/s,Dp=12cm2/s;符号“′”表示对其求导。
;G为电子-空穴对的体产生率;电子和空穴的扩散系数分别为:Dn=40cm2/s,Dp=12cm2/s;符号“′”表示对其求导。
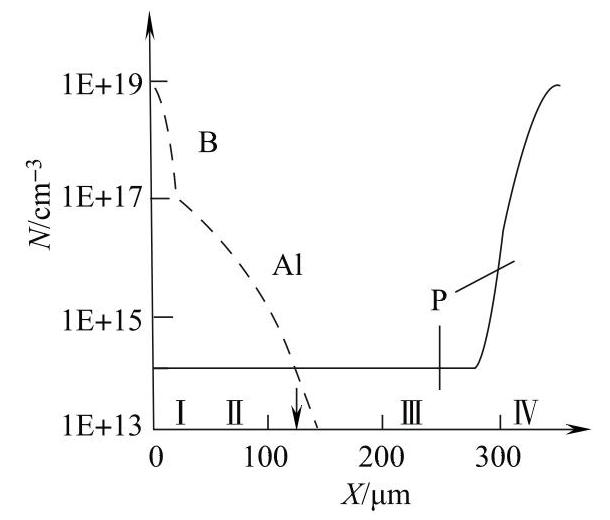
图4-77 SOS掺杂剖面图
在SOS的典型泵浦条件下,P+PNN+结构中会出现很高的电场,所以必须考虑函数Vn(E)和Vp(E)中漂移速率饱和的情况。采用插值公式:

式中,Vns和Vps分别为电子和空穴的饱和速率,Vns=107μm/ns,Vps=83μm/ns,在迁移率近似恒定情况下,Vn=μnE和Vp=μpE仍然有效;Ens和Eps为特征电场,Ens=7kV/cm,Eps=18kV/cm;βn和βp为调节系数,βn=1.11,βp=1.21。
式(4-44)适用于二极管结构的N区,位于PN结边界Xp的右边,这个边界相应于P型和N型杂质发生完全补偿的地方:N(xp-n)=0,空穴是少数载流子。在PN结左边的P区,电子是少数载流子,可得到类似的公式

其中Da,Va为与式(4-44)中相同的双极系数。

为与Qp有相似含义的频率参数。
以电子和空穴密度的平衡值作为函数n(x,t)、p(x,t)的初始条件,方程式(4-44)和式(4-45)的边界条件由二极管结构x=0和x=L处的金半接触特性决定,L为P+ PNN+结构的总长度。假设所有接触均为理想欧姆接触,载流子在二极管边界的密度相应于平衡密度:
n(0,t)=n2i/NA(0)
p(L,t)=n2i/ND(L)
其中ni=1.45×1010cm-3为硅中本征载流子密度。(https://www.xing528.com)
电子—空穴对的体产生率是离子化率I和载流子复合率R的差值:
G(n,p,E)=I(n,p,E)-R(n,p)
离子化率可表示为
I(n,p,E)=αn(n,p,E)n|Vn(E)|+αp(n,p,E)p|Vp(E)|式中,αn0(E)和αp0(E)为半导体中无移动载流子时的标准离子化系数,αn(n,p,E)=αn0(E)β(n,p,E),αp(n,p,E)=αp0(E)β(n,p,E);β(n,p,E)为考虑载流子的影响。
αn0(E)和αp0(E)的插值公式为
αn0(E)=Anexp(-Bn/|E|)
αp0(E)=Apexp(-Bp/|E|)
式中,An,Bn,Ap,Bp均为调整系数,An=7.4×105cm-1,Bn=1.16×106V/cm,Ap=7.25×105cm-1,Bp=2.2×106V/cm。

式中,Ei为硅离子化势能,Ei=1.5V;nion为具有密度量纲的参数,nion=2.4×1017cm-3。
在高密度电子-空穴等离子体中,主要的复合过程为深能级杂质复合Rimp和俄歇复合RAug:

RAug=(np-n2i)(Cnn+Cpp)
式中,τimp为粒子寿命;Cn,Cp为复合常数,Cn=6×10-31cm6/s,Cp=3×10-31cm6/s。
为了计算准中性等离子体模型的电场,引入总电流方程
jd(t)+jc(t)=j(t)
式中,jd(t)为位移电流密度,jd(t)=ε·E;ε为硅电介质常数,ε=11.7;jc(t)为传导电流;jc(t)=q(Dnn′+nVn(E)-Dpp′+pVp(E));电场的平衡剖面认为是初始分布E(x,0)。
通过二极管结构的电压计算公式为
UL=Ucont+∫0LE(x)dx
式中,Ucont为接触电动势差,Ucont=UTln(n(L)/n(0));UT为热电动势,UT=26mV。
US=NstUL为SOS堆上的电压,Nst为串联二极管芯片数目。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




