
图10.21 复合Ag纳米接头热循环前后拉伸强度
目前,半导体芯片的硅片键合采用富Pb高温钎料,利用复合Ag纳米颗粒可以替代这些高温钎料。但由于Si这种主要半导体材料的氧化物非常稳定,如图10.21所示,Si与Ag纳米颗粒的键合性能很差,因此需要在Si芯片的键合表面上镀Au。5mm正方形的镀Au的Si芯片与镀Au的5mm直径×25mm高的Cu圆柱进行键合,键合压力为1.0MPa和2.5MPa,键合温度为573K,时间为5min。在233~398K的温度范围内热循环500周,对接头进行热稳定性评定。图10.21所示为热循环前后接头的拉伸试验结果。图10.22所示为键合压力1.0MPa和2.5MPa条件下获得的接头在热循环前的截面微观组织BE图像。
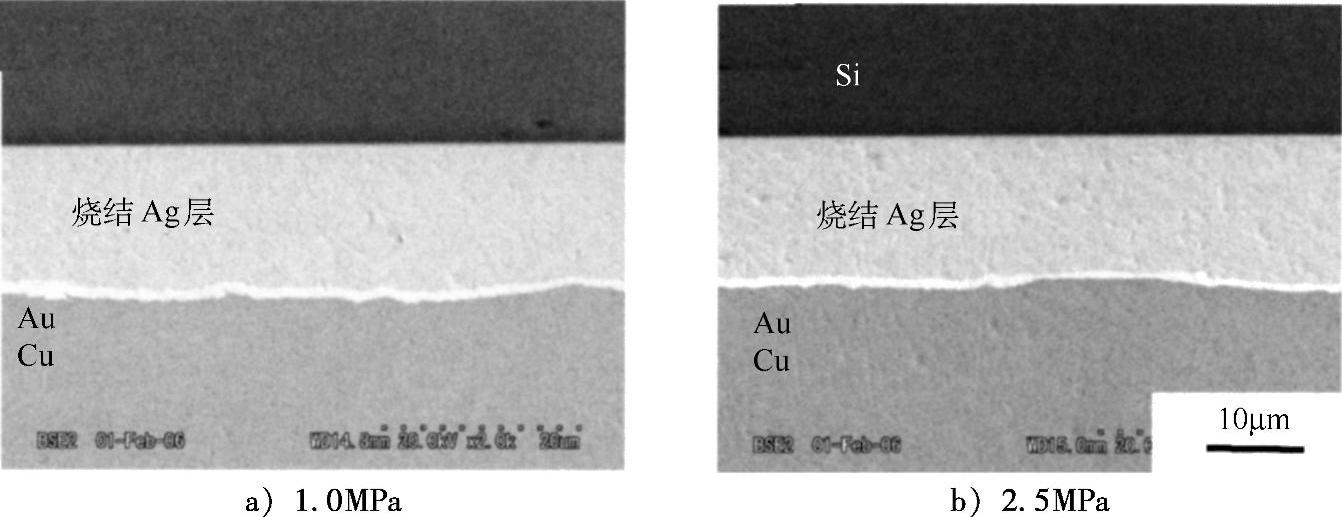 (https://www.xing528.com)
(https://www.xing528.com)
图10.22 复合纳米Ag键合Si芯片-Cu接头的热循环前截面微观组织BE图像
(键合温度为573K,键合压力)
热循环前两种键合强度下接头的拉伸强度约为25MPa左右。此外,图10.22表明接头中烧结Ag层很致密,没有任何裂纹或者未键合层。Si芯片与Cu/Au样品的断裂全部发生在Si芯片内部,因此烧结Ag层和Si芯片的界面强度可能具有超过25MPa的键合强度。但是经过热循环试验后,接头强度的改变取决于键合压力。经过热循环后,在键合压力1.0MPa下获得的接头强度弱化,但键合压力2.5MPa情况下的接头强度没有大的变化,如图10.21所示。结果表明,键合压力为1.0MPa的接头可能被热应力损伤。可见,采用适当的键合压力(2.5MPa)可以形成致密可靠的烧结Ag层,热循环后界面具有足够的键合强度。而且,我们采用纳米Ag复合颗粒成功地进行了镀Ag的Si芯片与镀Ag的Al基板的连接,接头经受了温度范围213~573K的热循环[13]。因此,采用复合Ag纳米颗粒可以用来实现Si芯片的键合。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




