在一个半导体中形成p型和n型两个区域,p型和n型的界面就是pn结。pn结具有单向导电性,是许多重要半导体器件的核心。
掺杂浓度较低的半导体与金属所形成的接触和pn结一样具有单向导电性(此时金属功函数>半导体功函数,材料的功函数是指材料的费米能级与真空能级之间的差值),其频率特性优于pn结。高掺杂半导体与金属形成的接触通常为低阻非整流接触(此时金属功函数<半导体功函数),几乎所有的电子器件中都利用它来实现欧姆接触。
1.金属—半导体结
典型的金属与半导体接触有两类:一类是整流接触,即制成肖特基势垒二极管,另一类是非整流接触,即欧姆接触。当一块金属和一块半导体接触时,能量达到平衡时,其费米能级一定要连续。图5-12示意了n型半导体与不同功函数的金属接触成结时能带结构变化的情况。假设金属功函数为Φm,半导体的功函数为Φs。当Φm>Φs时,电子从半导体流入金属,直到平衡。此时费米能级连续通过结,这是由于接近结的半导体中的电子,离开施主进入金属的结果。这个过程在半导体接近结的部分形成耗尽层。此时离子化的施主形成了正的空间电荷区,金属一边接触面形成负的表面电荷。耗尽区(或称势垒区,或者空间电荷区)之所以这样称呼它是因为它已经耗尽自由载流子,结果电阻很高。电子继续流动,直到双电层建立了足够强的电场,阻止电子继续流动,从而造成了在半导体一边能带向上弯,形成一个势垒为Φm-Φs(图5-12a)。此时由于热扰动,只有极少数电子从金属流向半导体而且半导体导带里只有极少的电子有足够能量越过势垒进入金属,在平衡时这二类电流相等,没有净电流通过结。另一方面,如果Φm<Φs,情况完全不同。电子将从金属流向半导体,引起表面电荷积累,直到平衡时费米能级连续通过结。最终内部自发形成的电场导致半导体的能带下降弯曲。在这种情况下,结处无势垒,电子通过结“来去”自由,这种结称为欧姆结(图5-12b)。

图5-12 金属—n型半导体成结前后的能带结构
a)Φm>Φs整流结 b)Φm<Φs欧姆结
类似的论证可以说明,当p型半导体与金属接触成结时,当Φm<Φs时形成整流结,而Φm>Φs时形成欧姆结。
对n型半导体的整流结,如果加上偏压V,半导体边与正极连接,金属边与负极连接,则半导体能带以eV值下降,这就导致了势垒进一步升高(势垒高度为│eV│+│Φm-Φs│),并使耗尽层宽度增加(图5-13b)。这种外加电压的条件称为加反向偏压。在这种条件下,从半导体流向金属的电子减少,因而势垒高度增大。但是电子从金属流向半导体并没有改变,那么此时的反向电流在一个低的V值就达到饱和,并且基本上与V无关。当外加电压极性改变,此时加的就是正偏压(图5-13c),那么阻碍电子从半导体向金属流动的势垒下降了│eV│。可以证明,此时的电流与正偏压成指数关系增加。这就是单向导电性,反向电流很小。单向导电称为整流,通常称肖特基整流。
上述讨论的情况是不考虑半导体表面能级的理想状态。不过,由于常用的半导体材料的表面能级密度很高,与金属接触都会形成势垒。所以实际工作中,常通过重掺杂半导体与金属接触,使其势垒很薄,电子可以通过隧道效应穿过势垒,从而形成欧姆接触。

图5-13 金属—n型半导体结的偏压效应(Φm>Φs)
a)零偏压 b)反向偏压 c)正向偏压
肖特基势垒二极管高频特性好,开关速度快,由于它是杂质引起的多数载流子在起作用,不是由于热产生的本征激发的少数载流子起作用,所以热噪声很低。
欧姆接触是设计和制造超高频、大功率器件的关键问题,因为半导体元件都需要通过电极引线与外部电路进行电学连接,而欧姆接触效应则广泛地应用于这些电极引线的设计生产中。
2.pn结
pn结是由单晶半导体上相邻的两个区——p型区和n型区构成的。n区掺施主杂质,浓度为nD;p区掺受主杂质,浓度为nA。为了便于理解,可以假想pn结是由同一种材料进行不同掺杂的两块样品紧密接触而形成的。那么在接触前,在人们所关心的温度和掺杂范围内,n型区的费米能级高于p型区的费米能级(参见图5-8,可认为接触前p型和n型的导带底部能量相等),在n型区存在自由电子以及相等浓度的正电离施主杂质原子,以保持电中性。在p型区存在自由空穴以及相同浓度的负电离受主杂质原子,以保持电中性。于是n型区的多数载流子是电子,p型区的多数载流子是空穴。在两区紧密接触后,一开始,由于两区的费米能级不同,电子和空穴的浓度不同,n区的电子通过扩散进入p区的未被电子占据态,降低了电子的能量。p区空穴也要向n区扩散。这种电荷转移的结果是在n区出现电离施主构成的正空间电荷区,而在p区出现电离受主构成的空间负电荷区,因此空间电荷区内就形成了从n区指向p区的电场,称为内建电场(图5-14)。它倾向于阻止n区电子和p区空穴越过分界面向对方扩散,换句话说,两区的能级发生了相对位移,最后当能级的相对移动使两侧费米能级拉平时,动平衡就达到了。动态平衡的条件是
eΦ=εF(n)-εF(p) (5-45)
式中,Φ是接触电势差;εF(n)和εF(p)分别为未接触前n型区和p型区的费米能级;e为电子电荷绝对值。
pn结最令人感兴趣的特征是,在平衡条件下,结的两侧存在式(5-45)给出的接触电势差,结果使n型区的电势比p型区高Φ。对电子而言,这意味着p型区一侧势能高于n型区势能,结区形成了电子势垒,其作用是阻碍电子向p区扩散。同理,对从p型区向n型区扩散的空穴而言,结区也是势垒。势垒的高度为eΦ。在空间电荷区内自由载流子数目很少,称为耗尽层,如图5-14b中所示的-xp至xn区域,显然该层是高阻层。耗尽层的宽度可以从泊松方程中求得。
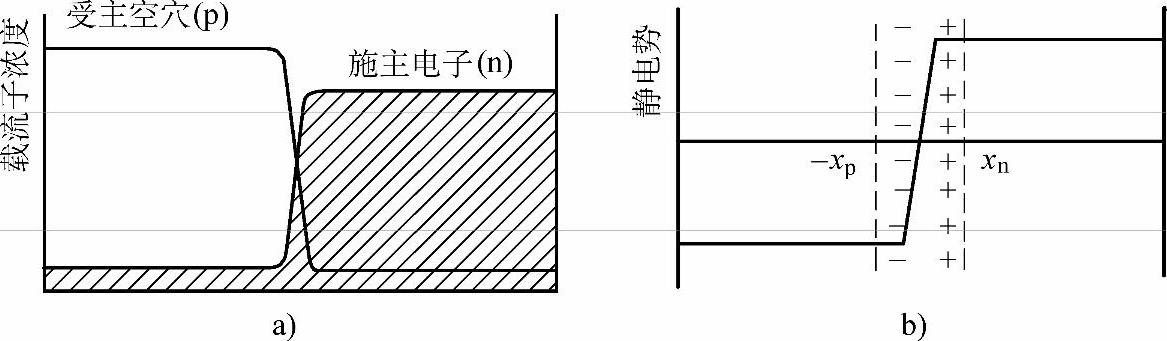
图5-14 pn结
a)无偏压时结区的空穴和电子浓度变化 b)受主负离子和施主正离子产生的内电场,从xp至xn称为耗尽层
pn结可以起整流作用。如果在结上施加某个方向的电压(p端接电源正极,n端接电源负极),将会有较大电流流动。但如果电压反向,那就只有很小的电流流动。如果在结上施加一个交流电压,那么电流主要向一个方向流动,这就是pn结的整流作用。pn结整流的原理如下所述。
原来p区相对于n区的电势为-Φ,如果加电压V0于p区,则p区相对于n区的电势改为-(Φ-V0),这时势垒高度为e(Φ-V0)。如果V0为正电压,则能带图中势垒将降低,如图5-15所示。在这种情况下,势垒不再能完全抵消电子和空穴的扩散作用。用p和n表示半导体类型,下标0特指热平衡情况,因此,nn0和np0分别是热平衡下n区和p区的电子浓度,pn0和pp0是热平衡下n区和p区的空穴浓度。
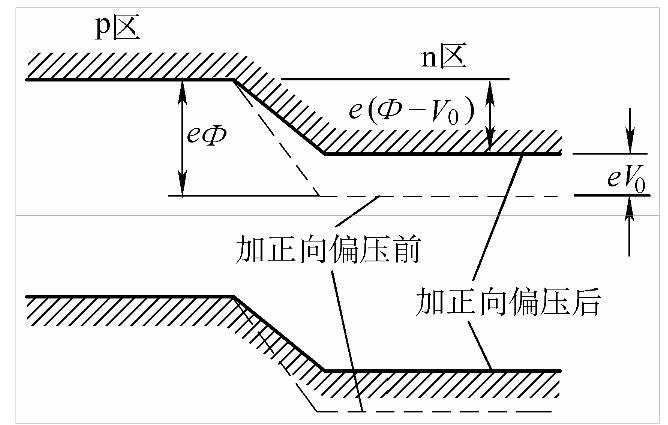
图5-15 正向偏压引起的pn结能带的改变
根据式(5-27)可知,在平衡条件下,电子浓度在n区和p区之比为

同理,根据式(5-29)可知,在平衡条件下,空穴浓度在p区和n区之比为

从上式可知,在热平衡条件下,在结两边耗尽层边界电子与空穴的浓度是与电势差Φ相关的,显然当施加外电压V0而引起静电势改变时,也应有同样的表达式。此时式(5-46)修正为

式中,nn和np分别是在n区和p区的耗尽层边界上非平衡电子浓度;V0为正时为正向偏置电压,V0为负时为反向偏压。在低注入条件下,注入的少数载流子浓度比多数载流子浓度小得多,因此nn≈nn0,将该条件与式(5-46)代入式(5-48),得到了p区耗尽层边界(x=-xp,参见图5-14b)的电子浓度为

即(https://www.xing528.com)

同理有n区耗尽层边界(x=xn,参见图5-14b)的空穴浓度为

从式(5-51)可见,由于外电压存在,注入的空穴不断向n区扩散,扩散流为 ,其中Dp表示空穴扩散系数。但由于它们是多余少数载流子,在扩散过程中又不断复合而消失。根据连续性方程,在稳态情况下,由扩散流不均匀而造成的积累率与非平衡载流子的净复合率相等,向n区扩散的空穴的积累率为
,其中Dp表示空穴扩散系数。但由于它们是多余少数载流子,在扩散过程中又不断复合而消失。根据连续性方程,在稳态情况下,由扩散流不均匀而造成的积累率与非平衡载流子的净复合率相等,向n区扩散的空穴的积累率为 。净复合率U与多余少数载流子浓度成正比,比例常数为1/τp,τp是描述多余少数载流子平均存在的时间,称为多余少数载流子寿命。在热平衡下U=0。净复合率U与多余少数载流子浓度的关系为
。净复合率U与多余少数载流子浓度成正比,比例常数为1/τp,τp是描述多余少数载流子平均存在的时间,称为多余少数载流子寿命。在热平衡下U=0。净复合率U与多余少数载流子浓度的关系为

利用式(5-52)可得

即

方程式(5-54)的边界条件为

则方程式(5-54)的解为

式中, ,是空穴在n区的扩散长度。在x=xn时,由空穴产生的电流密度Jp(xn)为
,是空穴在n区的扩散长度。在x=xn时,由空穴产生的电流密度Jp(xn)为

同理,可获得进入p区的电流密度Jn(-xp)为

这里,Dn表示电子扩散系数;Ln是电子的扩散长度。
因此,通过pn结界面的总电流J为

其中, 。由式(5-59)可以看出,在加正向偏压时,电流基本上按
。由式(5-59)可以看出,在加正向偏压时,电流基本上按 指数增加,在加反向偏压时,电流密度很快降到饱和值-J0。由此可以达到整流效应。
指数增加,在加反向偏压时,电流密度很快降到饱和值-J0。由此可以达到整流效应。
3.结晶体管和场效应管
结晶体管(俗称三极管),其主要功能是放大。图5-16a、b分别为pnp晶体管的共基极接线图和电子能带结构图。这种晶体管,中部是基极区,很薄,而且相对于发射极区的掺杂浓度也是很低的。其工作状态取决于多子和少子的相互作用。由于该器件涉及两种载流子,因此常把它归类为双极晶体管。图5-17所示为npn型晶体管共基极接线时的能带结构及载流子流动情况。

图5-16 pnp型结晶体管共基极接线 (a)及电子能带结构图 (b)

图5-17 npn型共基极晶体管的工作原理示意图
a)接线图 b)能带结构图 c)载流子浓度分布图
场效应管是另一种类型的晶体管,它也是集成电路中的基本器件。三极管和场效应管的基本差别在于:场效应管电流是仅靠多子输运形成的,多子流是控制电流,因此降低了对环境温度变化的敏感,以及其他外部因素的影响。场效应管有几种形式,主要有结场效应管和金属氧化物半导体场效应管。使用最多的是金属氧化物n型半导体场效应管,英文名字为n-MOSFET或NMOS,图5-18示意了它的结构。由图5-18可见,在p型硅基片上,制成两个孤立的n型硅区域。在这种器件中,电子进入的触点称源极,电子离开点为漏极,在n型硅的源和漏之间为p型硅区域,就在该p型硅的表面沉积一层SiO2,作为绝缘层。在SiO2的上面再沉积一层多晶硅或金属,以形成该晶体管的第三个接触点,它被称为栅极。因为SiO2是良好的绝缘体,因此栅极与它下面的p型硅电路上并不直接接触。对于简化的NMOS器件,当没有电压加到栅极上时,栅极下面的p型硅多数载流子是空穴,只有极少的电子被吸入漏极。当栅极加上正向电压时,这个电场从临近的n+源极和正好在栅极下面的也就是SiO2薄层下面的漏区域吸引电子,以至于使这个区域成为n型硅(图5-19)。当电子在该沟道内存在时,在源极和漏极之间存在导电通路。即存在正向电位差时,源极和漏极之间有电流流过。MOS场效应管同样具有放大功能,不过测量的是电压而不是电流。

图5-18 NMOS结构示意图
a)结构全貌 b)N沟道增强型MOS结构符号 c)结构横截面剖面图
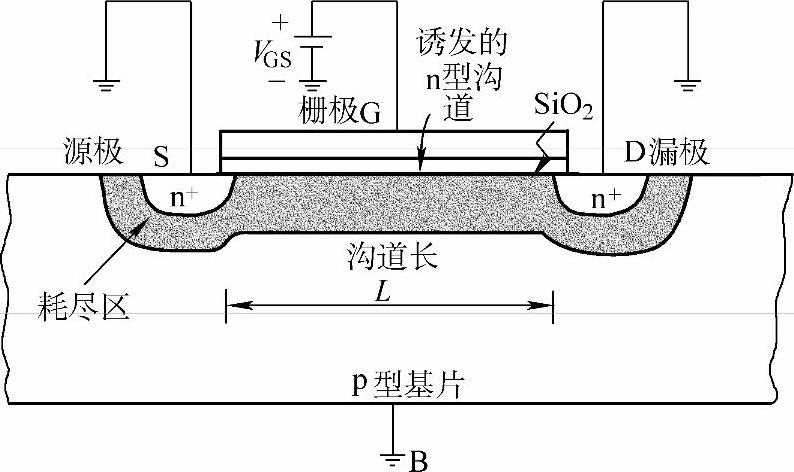
图5-19 具有正门电压VGS的理想NMOS器件
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




