1.薄发射极理论分析
RSD的预充过程可以等效为一个二极管电导调制的漂移模型。预充结束时大约75%的预充等离子体集中在P1层中,在开通过程中必须保证P1等离子层不被耗尽,因为它作为有效的电子源,在P+N二极管中起着阴极侧射极的作用。这种情况下的开通过程以准二极管模式进行。否则如果P1层耗尽,集电结将会趋于阻断,器件上电压迅速上升,出现类似晶闸管的局部化开通现象。
在导通过程中,注入和抽取电流动态地改变P1层中的电荷量,图4-24示出了这个过程。P1层不被耗尽的开通条件可以表示为

由式(4-21)可以得出这样的结论,P1层中的抽取电流JP1,extr应尽量减小以保证P1不被耗尽。
同时,当正向电流流过时,P+发射极向N基区注入空穴,表示为 ,它构成了N基区中的空穴电流。而N基区中的电子电流是
,它构成了N基区中的空穴电流。而N基区中的电子电流是 ,它们在不破坏体内电中性的条件下给N基区提供中间水平的注入,此过程也在图4-24中示出。因此,减小P+发射极的注入电流有利于减小P1层中的抽取电流,而使器件的开通更加均匀。
,它们在不破坏体内电中性的条件下给N基区提供中间水平的注入,此过程也在图4-24中示出。因此,减小P+发射极的注入电流有利于减小P1层中的抽取电流,而使器件的开通更加均匀。
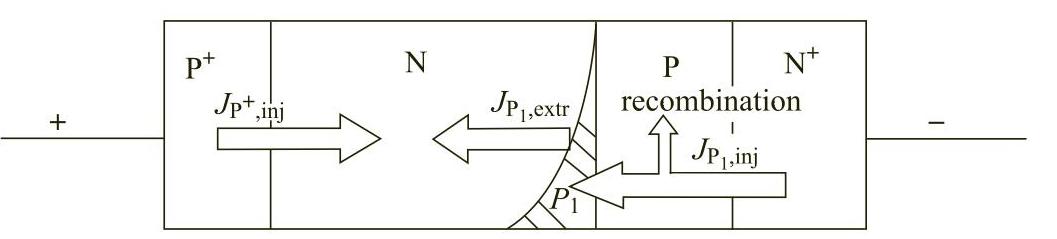
图4-24 晶闸管单元中的导通电流分布
在RSD中引入薄发射极是为了减小导通过程中阳极的空穴注入,比起常规结构,P+薄发射极的宽度要小、掺杂浓度要低一些。
在P1层不耗尽的条件下,RSD的导通过程可以等效为准二极管导通。在导通过程中,N基区和P基区都处于大注入状态,J2结被淹没。因此,薄发射极RSD的晶闸管部分可以等效为一个不对称的PIN二极管模型。图4-25是模型的示意图,同时给出了大注入下载流子的分布。
因为P+发射极很薄,少数载流子的梯度很陡以至于通过J1结的电流主要是电子的扩散电流。且由于朝J3结方向电子电流增加更多,所以基区中的空穴电流可以忽略。于是基区中的电场表示为

式中,p为I区中的空穴浓度。
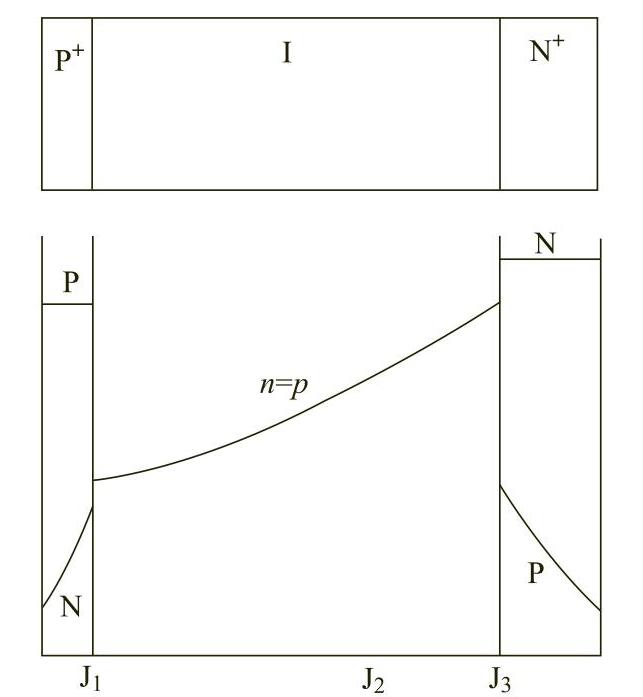
图4-25 不对称PIN二极管模型的结构示意图及大注入下的载流子分布
那么基区体压降可通过积分式(4-22)得到

式中,WB为I区宽度;p0和 分别为I区中J1结和J3结处的空穴浓度。
分别为I区中J1结和J3结处的空穴浓度。
因为P+发射极处于低注入水平,PN结定律的波尔兹曼关系成立,可以得到总的结压降如下

式中,nI是本征载流子浓度。
根据式(4-23)和式(4-24),得到忽略了发射极体压降和接触压降的正向压降表达式为

如果可以求出I区载流子分布,则UF′可求。前已述及,I区空穴电流予以忽略,则电子电流密度Jn就等于总电流密度J

由式(4-25)和式(4-22)以及电中性条件p=n得
 (https://www.xing528.com)
(https://www.xing528.com)
通过积分式(4-26),加上边界条件,可以得到载流子分布。最终得到不对称PIN二极管模型在大注入水平下i区的载流子分布的表示式

其中Q表示P+发射区单位面积的掺杂量,Dn′是P+发射极中的电子扩散系数,a和pc是与温度有关的常数。当T=300K,求得a=3.24×1018cm-1·s-1,pc=9.39×1016cm-3。所以

式(4-27)为忽略了发射极体压降和接触压降时正向压降的表达式。事实上,在薄发射极结构中Q值被限制得较低,因此当P+发射极足够宽,P+发射极体压降UbE不能忽略。假设P+发射极的电子呈线形分布,考虑到其电流为电子的扩散电流、空穴和电子的漂移电流之和,容易计算出VbE为

np1是P+发射极中J1结处的电子浓度,np1=JWE/qDn′。
假设电极接触为欧姆接触且接触压降忽略不计,则式(4-27)和式(4-28)相加便是PIN二极管模型的RSD正向压降的最后表达式
UF=U′F+UbE
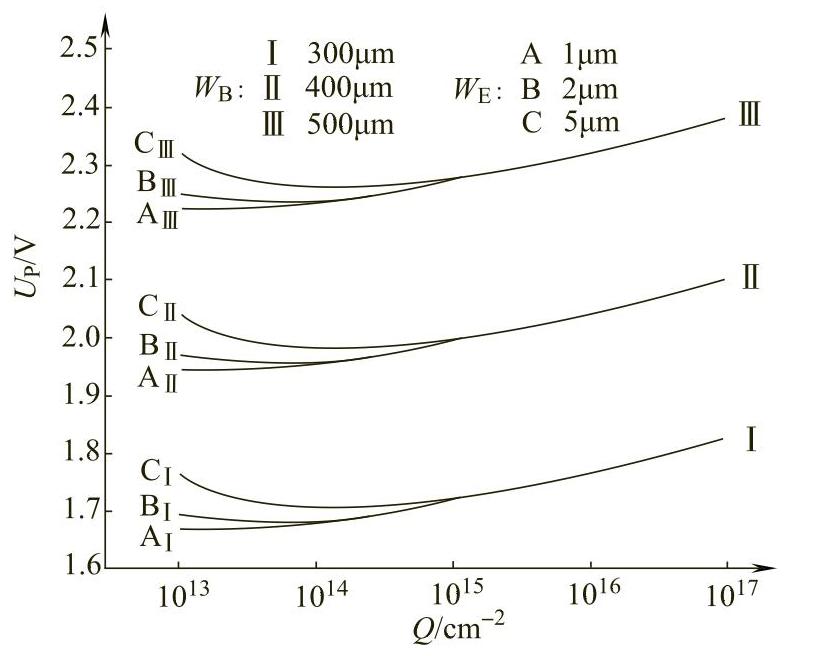
图4-26 薄发射极RSD正向压降随Q变化的模拟曲线
2.计算结果与讨论
设置参数为J=556A·cm-2,Dn′=35cm2s-1,μn=1350cm2V-1·s-1,μp=500cm2·V-1·s-1。图4-26是在一定的发射区和基区宽度下薄发射极RSD正向压降随Q变化的模拟曲线,对图线的分析如下:
1)在一定的WB、WE下,UF随Q的变化有极小值UF∗。设UF∗对应的Q值为Q∗,当Q≥Q∗时UF随Q减小而减小,这是由于由前面结压降UJ和基区体压降UbB的计算式知,Q的减小会使UJ减小而使UbB增大,而阴极高掺杂的N+发射极对基区有较大注入,使得UbB增大不多,总的趋势仍是使UF下降;当Q≤Q∗时UF随Q减小反而增大,这是由于Q的减小使得P+发射极的体压降不能再忽略,UbE增大而使UF上升。对于WE极薄的情况(如WE=1μm),当Q≤Q∗时,UF不随Q变化而趋于一恒定的值,这将有利于改善器件的一致性。
2)在一定的WB下,Q小到一定程度时,UF随WE的减小而减小,这是因为WE的减小使得UbE减小。当Q较大时UbE对UF的影响可忽略,UF与WE的大小无关,只随Q和WB的增加而增加。
3)在一定的Q和WE下,UF随WB的减小而减小,这是由于WB的减小使UbB减小所致。
总的来说,通过降低P+发射区的掺杂浓度可以减小RSD的正向压降,而当掺杂浓度变得很低时(如WE=5μm时Q≤1×1014cm-2)则有必要减小P+发射区的宽度来保持低压降。需要说明的是,计算拟合的曲线表明在电流密度较小的情况下通过薄发射极减小RSD压降的效果是明显的,但随着电流密度的增大,基区体压降在RSD总压降中占的比重上升,此时RSD正向压降受发射区的影响则不大了。
3.薄发射极的工艺实现与评价
通过Al烧结的工艺来制作薄发射极。在阳极和阴极的N+发射区制备完毕后,在阳极面的N型Si上进行Al烧结。通过降温过程控制Al在Si中的平均分凝系数,使在降温过程中析出的再结晶层形成P+薄发射极,而其余的Al作为金属电极。
图4-27a表示了RSD样品芯片解剖后、Al烧结工艺形成的RSD薄发射极的场发射扫描电镜(Field-emission Scanning Electron Microscope,FSEM)断面微观形貌扫描图片,图示为放大3000倍的情况,可以看到结面是平坦的。图4-27b是该样品的微区能谱成分分析及线分布(Energy Dispersive Spectrum,EDS),可读得合金层厚度约为2.27μm。根据Al在Si中的固溶度,P+发射区的掺杂浓度在1017~1018cm-3量级,因此薄发射极的条件是满足的。
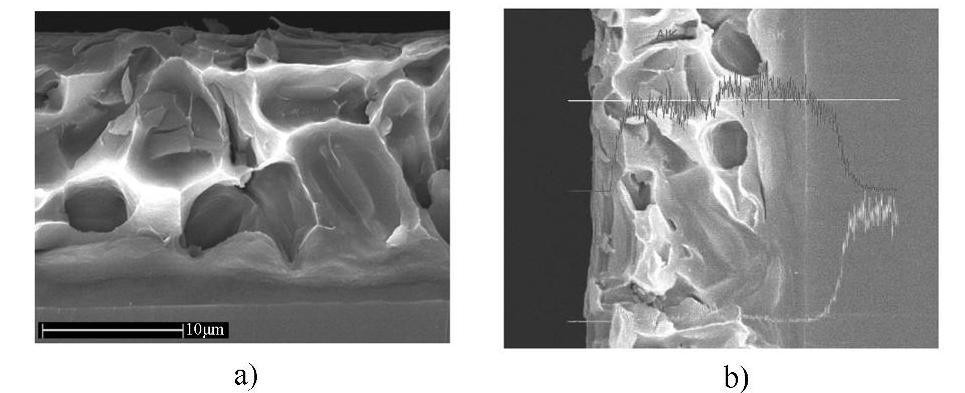
图4-27 RSD薄发射极的场发射扫描电镜(FSEM)断面微观形貌扫描图片和微区能谱成分分析及线分布(EDS)
a)FSEM图像 b)EDS结果
编号为2-1-4的两芯片串联的薄发射极RSD器件在开通试验平台上进行了测试。实验条件如下:主电容为10μF,主电压为2.5kV,预充回路电容为1μF,预充回路电压为1.3kV,负载电阻为0.25Ω,可饱和磁开关绕线3匝。监测设备为泰克公司示波器TDS2024。图4-28表示了开通电流和电压的示波图,换流峰值为5500A,从电压波形来看没有尖峰,这表明开通过程均匀。总开通电压15V,则平均到每只管芯为7.5V,表明在RSD中引入薄发射极对改善其开通特性是确实有效的。

图4-28 No.2-1-4薄发射极RSD开通示波图
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




