光刻技术是半导体工艺中非常关键的工艺。通常把线宽作为光刻工艺水平的标志,一般用加工图形的最小线宽来表征半导体工艺水平。功率分立器件和PIC芯片相对于普通IC的线宽较宽,目前基本不受光刻工艺水平的限制。
1.光刻技术
光刻(Lithography)是一种图形复印和化学腐蚀相结合的精细表面加工技术。目的是在二氧化硅或金属薄膜表面刻蚀出与掩模版完全对应的几何图形,从而实现扩散、离子注入、氧化及外延等定域工艺,及金属布线或表面钝化。光刻工艺流程一般分为七个步骤,即涂胶、前烘、曝光、显影、坚膜、刻蚀及去胶。
(1)涂胶(Priming) 目的是在硅片表面形成厚度均匀、附着性强、没有缺陷的光刻胶薄膜。在涂胶之前,硅片一般需要经过脱水烘焙,并涂上能增加光刻胶与硅片表面附着能力的化合物,通常称为打底膜。目前应用较多的打底膜是六甲基乙硅氮烷(Hexa-Methyl-Disilazane,HMDS)或三甲基甲硅烷基二乙胺(Tri-Methyl-Silyl-Diethyl-Amine,TMSDEA)。
光刻胶(Photoresist)是由抗蚀剂(聚合物或树脂)、感光剂[光敏化合物(PAC)]及溶剂组成。根据抗蚀剂在曝光前后溶解性的变化来划分,抗蚀剂可分为正性抗蚀剂和负性抗蚀剂。负性抗蚀剂曝光后不溶于显影液,具有感光度或灵敏度高(即分辨能力弱)、稳定性好、针孔少、耐腐蚀及附着性好等特点,主要用于线宽大于3μm的分立器件。正性抗蚀剂曝光后可溶于显影液,具有分辨能力强(即感光度或灵敏度低)、对比度较高、线条边沿好、寿命长及不易发生热膨胀等优点,主要用于线宽小于3μm的大规模和超大规模集成电路。
采用负性光刻胶和正性光刻胶在硅片表面所得到的光刻图形不同。负性光刻胶光刻后得到的芯片表面图形与光刻版上的图像正好相反,是掩模图像的负影像。正性光刻胶光刻后得到的芯片表面图形与光刻版上的图像相同,是掩模图像的正影像。在晶闸管类器件制作过程中,一般需要3~5次光刻,由于线条较粗,采用负性光刻胶即可;在IGBT芯片制作过程中,需要6~8道光刻工艺,可采用正、负性光刻胶相结合。为了提高分辨率,还可以采用多层光刻胶工艺。
(2)前烘(Pre-Bake或Soft Bake) 涂胶以后的硅片,曝光前需要在一定的温度下进行烘烤,故称为前烘。一般前烘温度约为80℃,恒温时间为10~15min。通过前烘,可以使溶剂从光刻胶内挥发出来,从而降低灰尘的沾污,同时可减轻因高速旋转形成的薄膜应力,提高光刻胶的附着性。前烘的温度和时间要严格控制,如果温度过高,不仅会使光刻胶层与硅片表面的黏附性变差,曝光的精确度变差,而且会使显影液对曝光区和非曝光区光刻胶的选择性下降,并使光刻胶中的感光剂发生反应,导致光刻胶在曝光时的敏感度变差,图形转移效果不好。
(3)曝光(Exposure) 光刻过程的关键步骤是曝光。曝光就是通过曝光源将掩模图形转移到抗蚀膜上,在基片的抗蚀膜上形成微细的加工图形。掩模通常采用金属铬/玻璃版。曝光光源有紫外光(UV)、深紫外光(DUV)电子束及X射线。曝光时要求掩模图形与先前刻蚀在晶片上的图形能精确对准,采用逐步对准技术可补偿硅片尺寸的变化,提高对准精度,也可以降低对硅片表面平整度的要求。半导体器件制作需要经过多次光刻,要求在各次曝光图形之间都要相互套准。当图形线宽在1μm以下时,通常采用自对准技术来实现精密的套刻对准。
光学曝光方法有接触(Contact)式、接近(Proximity)式和投影(Projection)式,以及分步重复(Step-repeat)曝光。分步重复曝光是通过缩小投影系统成像,不需要1∶1精缩掩模,使得掩模尺寸较大,制作方便;并且因使用了缩小透镜,原版上的尘埃、缺陷也相应地缩小,因而可减小原版缺陷的影响。电子束曝光是把各次曝光图形用计算机设计,改变图形时只要重新编程即可,不要掩模版,因而改变光刻图形也十分简便。由于电子束的斑点可以聚焦得很小,且聚焦的景深很深,可用计算机精确控制,分辨率高,但设备复杂,成本较高,曝光图形存在邻近效应。
曝光质量与曝光时间、光线平行度、光刻版的质量和分辨率、光刻版和抗蚀剂的接触情况及抗蚀剂的性能和膜厚等因素有关。
(4)显影(Develop) 在曝光之后,为了显示出光刻胶膜的图形,需要进行显影。在显影过程中,正胶曝光区和负胶非曝光区的光刻胶在显影液中溶解,于是在光刻胶层中形成了潜在图形,显影后便显现出光刻胶的三维图形,作为后续工艺的掩膜。严格地说,显影时曝光区与非曝光区的光刻胶都有不同程度的溶解,光刻胶溶解速度反差越大,显影后得到的图形对比度越高。
显影方式有多种,目前广泛使用喷洒方法。先将硅片放在旋转台上,并在硅片表面喷洒显影液;然后将硅片在静态下进行显影,显影液在没有完全清除之前,仍然会起作用,所以显影后需要对硅片进行漂洗和甩干。显影效果与曝光时间、前烘温度和时间、光刻胶膜厚度、显影液浓度和温度等因素有关。
(5)坚膜(Post-Bake或Hard Bake) 是在一定温度下对显影后的硅片进行烘焙,除去显影时胶膜所吸收的显影液和残留的水分,改善胶膜对基片的黏附性,增强胶膜的抗蚀能力。坚膜温度一般为140℃,时间约为40min[27]。
坚膜的温度和时间要选择适当。坚膜不足,则抗蚀剂胶膜没有烘透,膜与硅片黏附性差,腐蚀时易浮胶;坚膜温度过高,则抗蚀剂胶膜会因热膨胀而翘曲或剥落,腐蚀时同样会产生钻蚀(即横向腐蚀)或浮胶。要求坚膜的温度稍高于光刻胶的玻璃态转变温度。在此温度下,光刻胶软化,可使光刻胶在表面张力的作用下平坦化,以减少光刻胶膜中的缺陷(如针孔),并修正光刻胶图形的边缘轮廓。温度太高(在170~180℃以上)时,聚合物会分解,影响黏附性和抗蚀能力。
此外,对于腐蚀时间较长的厚膜刻蚀,可在腐蚀一半后再进行一次坚膜,以提高胶膜的抗蚀能力。
(6)刻蚀(Etch) 对坚膜后的硅片进行刻蚀,去除光刻窗口处的氧化层,暴露出硅衬底,以便于进行后续的选择性扩散工艺或薄膜生长工艺等。关于刻蚀的方法将在8.3.4节中详细说明。
(7)去胶(Photoresist Strip) 在腐蚀之后,需要将硅片表面的光刻胶去掉。去胶(Photoresist Strip)方法包括湿法去胶和干法去胶。湿法去胶又分为有机去胶剂去胶和无机去胶剂去胶。有机去胶剂去胶主要是将光刻胶溶于有机溶剂中,从而达到去胶的目的。对SiO2、Si3N4、多晶硅等非金属衬底上的光刻胶,通常采用无机去胶剂去胶,即采用浓硫酸(H2SO4)和双氧水(H2O2)按3∶1配成混合液,将光刻胶中的碳元素氧化成为二氧化碳,就可把光刻胶从硅片表面上除去。对Al、Cr金属衬底上的光刻胶,因为无机溶液对金属有较强的腐蚀作用,需采用专门的有机去胶剂。有机去胶剂主要有丙酮和芳香族有机溶剂,同时用三氯乙烯作为涨泡剂,因其毒性较大且三废处理困难,实际工艺中较少使用。
干法去胶包括紫外光分解去胶和等离子体去胶[1]。紫外光分解去胶是指光刻胶薄膜在强紫外光照射下,分解为可挥发性气体(如CO2、H2O),被侧向空气带走。等离子体去胶是利用氧气产生的等离子进行反应刻蚀,让硅片上的光刻胶在氧等离子体中发生化学反应,生成气态的CO,CO2及H2O,由真空系统抽走。通常用紫外光分解去除表层胶,等离子体去除胶底膜。与湿法去胶相比,干法去胶操作简单、安全,处理过程中引入污染的可能小,并且能与干法腐蚀在同一台设备内完成,不会损伤下层衬底表面。但干法去胶存在反应残留物的沾污问题,因此干法去胶与湿法去胶经常搭配进行。
2.刻蚀技术
显影后在光刻胶膜上形成的微图形,只给出了器件的形貌,并不是真正的器件结构图形,还需要通过刻蚀工艺将光刻胶膜的图形转移到晶片表面的各层材料(如Si、SiO2或金属膜等)上,才能得到与抗蚀膜图形完全对应的晶片表面图形。
(1)指标要求 通常用保真度、选择比、均匀性及清洁度等指标来衡量刻蚀图形的质量。
1)保真度(Fidelity) 转换图形的保真度Af可以用刻蚀后的图形尺寸来表示:

式中,df表示掩蔽膜窗口的尺寸,dm表示刻蚀窗口的尺寸,h为刻蚀的深度。当df=dm时,Af=1。此外,Af与纵、横向腐蚀速率有关,也可表示为[4]:

式中,vv为纵向腐蚀速度;vl为横向腐蚀速度。保真度Af通常在0~1之间。横向速率越小,保真度越高,即掩膜上的图形可以不失真地转移到硅片表面。
根据刻蚀剖面图形,将刻蚀效果分为各向异性(Anisotropic)和各向同性(Isotropic),如图8-16所示。各向异性是指vv>>vl,即Af=1(理想情况);各向同性是指vv=vl,即Af=0。多数湿法刻蚀和少数干法刻蚀呈现各向同性。实际情况往往是不同程度的各向异性,故保真度也称各向异性度。
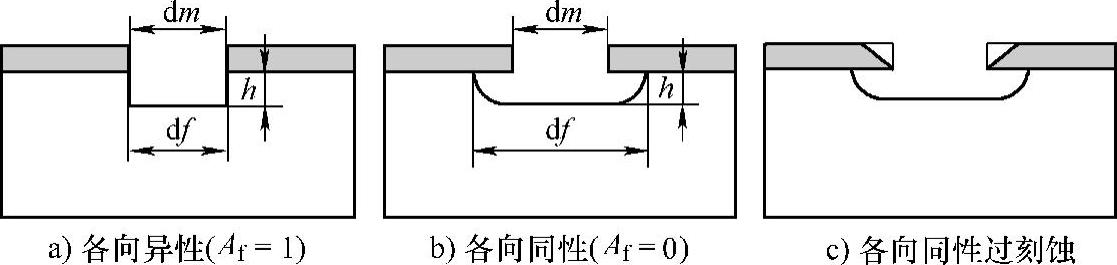
图8-16 刻蚀剖面示意图
2)选择比(Selectivity) 是指不同材料间的腐蚀速率之比,是度量被刻蚀材料和表面其他材料刻蚀速率相对大小的量。比如刻蚀SiO2时,要求对光刻胶和硅衬底的刻蚀速率很低,而对SiO2的刻蚀速率要很高。图8-16c所示为过刻蚀的示意图,其中对硅衬底进行刻蚀的同时,窗口的光刻胶也被刻蚀掉一部分。
刻蚀的选择比Sfm可用下式来表示:

式中,vf表示对薄膜的腐蚀速率,vm表示对掩蔽膜或衬底的腐蚀速率。选择比Sfm的大小与工艺参数相关,如湿法刻蚀的腐蚀液浓度、温度等有关,干法刻蚀的等离子体参数、气压及气体流量等。一般要求Sfm在25~30之间比较合理。(https://www.xing528.com)
3)均匀性(uniformity) 刻蚀的均匀性可用平均厚度、平均刻蚀速率及刻蚀时间差来表示。刻蚀速率为刻蚀厚度与刻蚀时间的比值。设硅片平均厚度为h,各处厚度的变化因子为δ(0≤δ≤1),则硅片最薄处厚度为h(1-δ),最厚处厚度为h(1+δ);又设平均刻蚀速率为v,各处刻蚀速率的变化因子为ξ(0<ξ<1),则硅片最小刻蚀速率为v(1-ξ),最大刻蚀速率为v(1+ξ),则刻蚀时间差可用下式计算[3]:

由于实际硅片不同位置的表面状态不同,导致腐蚀速率也不同,会出现过刻蚀或欠刻蚀。刻蚀时间过长、刻蚀速率和膜层厚度不均匀,都会引起过刻蚀。
4)清洁度 在腐蚀过程中,如果引入玷污,既会影响图形转移的精度,又增加了腐蚀后清洗的复杂性和难度。比如在干法刻蚀过程中出现的聚合物再淀积,将会影响刻蚀质量;在接触孔部位的重金属玷污将会引起结漏电。
(2)刻蚀方法 包括湿法刻蚀(Wet Etch)和干法刻蚀(Dry Etch)。由于两种刻蚀方法的作用机理不同,刻蚀效果也不同。图8-17给出了湿法刻蚀和干法刻蚀的剖面示意图。可见,湿法刻蚀在各方向上以同样的速度进行刻蚀,刻蚀后的剖面为各向同性;干法刻蚀仅在一个方向刻蚀,刻蚀后的剖面为各向异性。
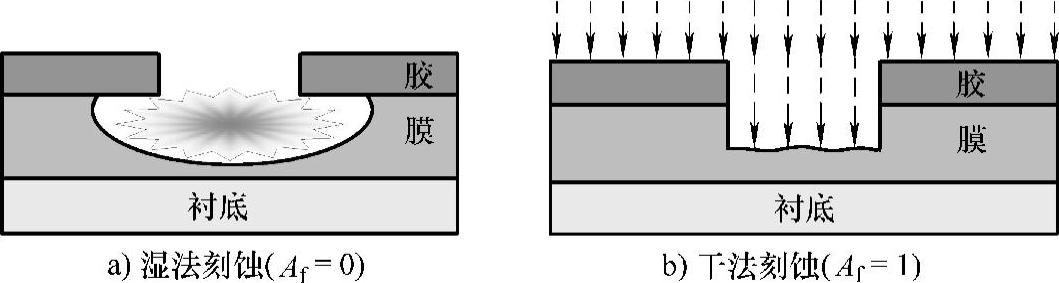
图8-17 湿法和干法刻蚀剖面示意图
1)湿法刻蚀。是利用化学反应进行接触型腐蚀。湿法刻蚀的主要参数有腐蚀液浓度,腐蚀时间,反应温度以及溶液的搅拌方式。湿法刻蚀可处理的材料包括硅(Si)、二氧化硅(SiO2)、氮化硅(Si3N4)及铝(Al)。
SiO2膜常用氢氟酸(HF)来腐蚀,HF与SiO2反应生成六氟硅酸(H2SiF6),由于H2SiF6是可溶性的络合物,使SiO2被HF溶解。其化学反应式如下:

还可以用氟化铵(NH4F)与HF的混合液来腐蚀SiO2膜,NH4F∶HF(40%~49%)为6~7∶1(体积比),其中NH4F为缓冲剂,可分解成氨气和HF,以补充腐蚀过程中HF的消耗。其化学反应式如下:

Al的腐蚀常用热H3PO4与乙醇(比例按70∶30)的混合液,温度为80~85℃。其化学反应式如下:

Si的腐蚀可以用酸性腐蚀液和碱性腐蚀液。酸性腐蚀液为氢氟酸(HF)、硝酸(HNO3)及醋酸(CH3COOH)按一定配比制成的混合液,先用强氧化剂对硅片进行氧化,再用HF与SiO2反应去掉氧化层。其化学反应式如下:

碱性腐蚀液为KOH水溶液与异丙醇(IPA)相混合,腐蚀速度ve取决于晶向,由于不同晶向原子面密度不同,其腐蚀速度的顺序为ve(100)>ve(110)>ve(111)。
图8-18所示为不同晶面的硅腐蚀后剖面示意图[3]。对(100)晶面,当腐蚀窗口较小时,会形成V形槽;当腐蚀窗口较大或时间较短时,会形成开口较大的掩蔽膜U形槽(见图8-18a);对(110)晶面,不论窗口大小,会形成侧壁陡直的U形槽(见图8-18b)。

图8-18 不同晶面腐蚀后的剖面示意图
2)干法刻蚀。是利用等离子体激活化学反应或者利用高能离子束轰击去除物质的方法。由于刻蚀过程不使用溶液,称之为干法刻蚀。干法刻蚀适合小于3μm宽的窗口刻蚀。干法刻蚀方法包括溅射刻蚀(Sputter Etching,SE)、等离子体刻蚀(Plasma Etching,PE)和反应离子刻蚀(Reactive Ion Etching,RIE)。溅射刻蚀是用惰性气体活性离子(Ar+)轰击待刻蚀材料,控制机制为物理溅射,刻蚀效果为各向异性。等离子体刻蚀是利用辉光放电产生化学活性离子的化学反应来进行刻蚀,是一种选择性刻蚀方法,控制机制为化学反应,刻蚀效果为各向同性。反应离子刻蚀是利用具有活性的化学反应离子去轰击待刻蚀材料,控制机制是化学反应与物理溅射相结合,刻蚀效果为各向异性,并具有一定的选择性。
硅、氧化硅及氮化硅的刻蚀通常用CF4、CHF3、C2F6,SF6及C3F8等气体源产生的活性氟基(用F*)。多晶硅刻硅用Cl2,HCl和SiCl4等产生的活性氯基(Cl*)。化学反应如下:

SiO2/Si的选择性随C/F的增加而增加,刻蚀速率与氧化层的生长方法有关。热生长的SiO2膜刻蚀速率低于CVD形成的SiO2膜,PECVD法形成的Si3N4膜的刻蚀速率则高于LPCVD法形成的Si3N4膜。
表8-3为各种材料常用的刻蚀剂。硼硅玻璃(BSG)常用氢氟酸(HF)和氟化铵(NH4F)腐蚀,但如果硼含量过高,则必须采用干法刻蚀、物理喷砂或研磨等物理方法。
表8-3 各种材料常用的刻蚀剂

通常用干法刻蚀进行沟槽刻蚀。设槽深为h,槽宽为w,则沟槽的深度和宽度之比,即深宽比(Aspect ratio,AR),可用下式来表示:

沟槽深宽比(AR)越大,刻蚀难度就越大。沟槽扩展型SJMOS结构的AR可达到18[28],此时需要采用深硅刻蚀工艺。
深硅刻蚀通常选用感应耦合等离子(Inductively Coupled Plasma,ICP)刻蚀设备[29]。ICP刻蚀过程包括复杂的物理和化学反应。物理反应过程是利用反应腔体内的离子对样品表面进行轰击,使化学键断裂,以增加表面的黏附性,同时促进表面生成非挥发性的残留物等;化学反应是利用刻蚀气体通过辉光放电,使腔体内的各种离子、原子及活性游离基等发生化学反应,同时这些粒子也会和基片表面材料反应生成气体,形成刻蚀的沟槽。
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




