1.“超结”的提出
功率MOSFET由于不存在电导调制效应,通态功耗较高。要降低通态功耗就必须减小导通电阻Ron。击穿电压主要体现在P区与漂移层形成的PN结上,因此要获得高击穿电压必须使漂移层有较大的厚度和较低的掺杂浓度。所以击穿电压与导通电阻是一对矛盾!导通电阻受击穿电压限制而存在一个极限——“硅限”,满足如下关系
Ron=5.93×10-9U2B.5
1988年,飞利浦美国公司的D.J.Coe申请美国专利,第一次给出了在横向高压MOSFET中用交替的PN结构代替传统功率器件中低掺杂漂移层作为电压支持层的方法。1993年,我国电子科技大学陈星弼教授申请美国专利,提出在纵向功率器件(尤其是纵向MOSFET)中用多个PN结结构作为漂移层的思想,并称为“复合缓冲层”。1995年,西门子公司的J.Tihanyi申请美国专利,提出了类似的思路和应用。1997年,Tatsuhiko等人提出“超结理论”(Superjunction Thoery),继而这一概念广为流传,被学术界所承认。1998年,Infineon公司推出CoolMOSTM产品,是这一理论得以应用的典型代表。
如我国陈星弼教授提出的复合缓冲(Composite Buffer,CB)耐压结构(1993年美国发明专利U.S.PAT.NO.5,216,275,1991年中国发明专利ZL9111845.X)器件具有速度快、导通电阻低、易驱动等优点,有许多具体结构,适用于各种半导体功率管。对于最简单的结构用于硅功率MOSFET,满足
Ron≈C·UB1.32
式中,C为与元胞尺寸及复合层厚度有关的常数。
可见,超结结构使UB与Ron几乎呈线性关系,打破了“硅限”。对耐压1kV的硅功率MOSFET,导通电阻可比传统结构小一百多倍。
2.超结MOSFET的工作原理(https://www.xing528.com)
以一N型CoolMOSTM为例说明超结MOSFET的工作原理,结构图如图3-13所示。它在漂移层插入P-区进行电荷补偿,以提高击穿电压和降低导通电阻。器件加偏压时,横向产生电场使横向PN结耗尽,起到电压支持层的作用。器件耐压能力主要取决于漂移层厚度,作为电流通路的N区掺杂浓度可大幅提高(将近一个数量级),相当于为导电电子“铺设”了一条低阻通路,使Ron大大降低。它与传统MOSFET一样还是多子器件,可同时得到低通态损耗和高开关速度。
我们知道,在开关开通状态下,需要大量的载流子,而在关断状态下基本不需要。在关断状态下净电荷被相互平衡至零,而在导通状态下其中一种载流子参与导电,且它的掺杂浓度并未降低,这就是补偿原理的思想。我们也可试图从电力线的角度去解释这种横向结构设计的优势。在器件关断时,P型区和N型区都被耗尽,受主和施主电离产生负电荷和正电荷,由于P区和N区相间排列,N区正电荷产生的电力线将有一部分沿横向终止于P区,而不是像单一掺杂类型的漂移区那样只能沿纵向消失于电极处。这样,从外部来看,漂移区的等效电荷密度就被降低了。所以,即使漂移区掺杂较重,也能做到与轻掺杂的单一漂移区相同的耐压。
功率器件的设计思想突破了传统的纵向结构设计,逐渐向横向结构设计转化,超结——不仅可用于功率MOSFET,也可用于PIN二极管、晶体管、SIT等。图3-14表示了各种复合缓冲层的元胞示意图。
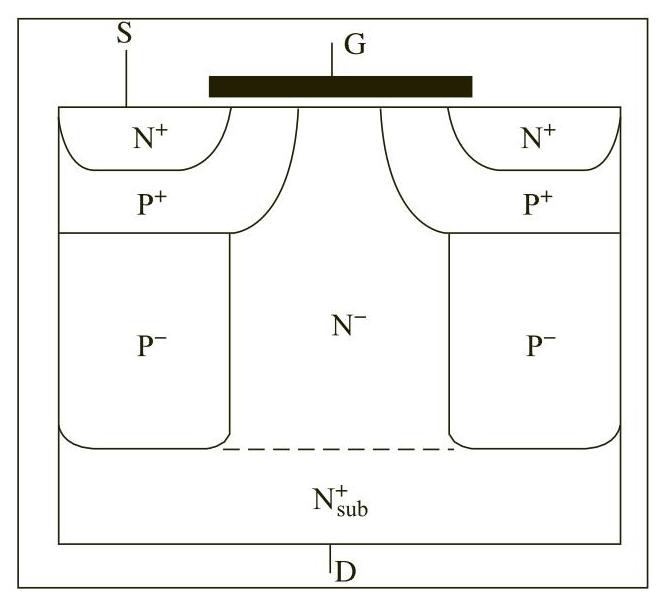
图3-13 N型CoolMOSTM结构图
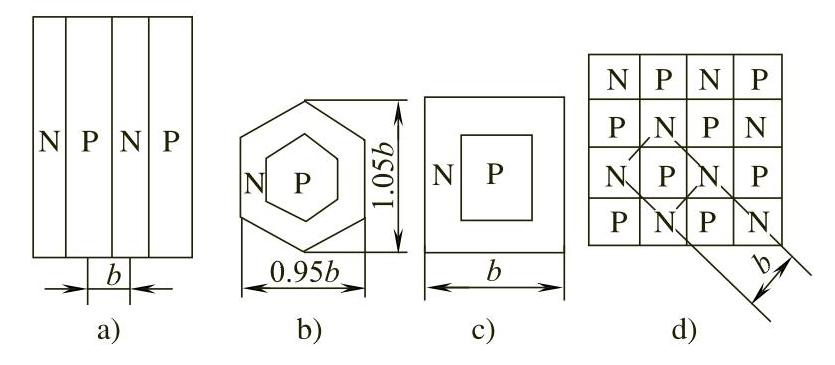
图3-14 各种复合缓冲层元胞示意图
a)叉指式 b)六角形 c)方形 d)格子形
免责声明:以上内容源自网络,版权归原作者所有,如有侵犯您的原创版权请告知,我们将尽快删除相关内容。




